최신 FC-BGA는 20층 넘나들어
일단 내년 상반기 양산 목표
SKC 자회사 앱솔릭스가 TGV(글래스관통전극) 기판 위에 ABF(아지노모토빌드업필름)를 2단 적층 하는데 성공한 것으로 알려졌다. 인텔이 오는 2030년 이전 양산 적용을 천명한 글래스 코어기판은 TGV 기판 위에 ABF를 쌓아가며 회로를 빌드업한다.
신생 업체인 앱솔릭스는 ABF 공정 노하우가 기존 패키지 기판 경쟁사들 대비 열세일 수 밖에 없다.
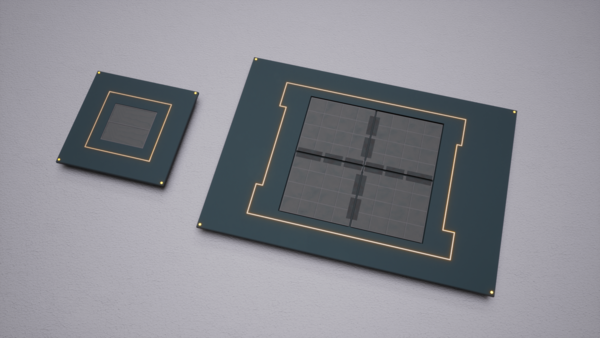
앱솔릭스, ABF 2단 적층 성공…6층 도전
글래스 코어기판의 기본 구조는 CPU⋅GPU 패키지에 쓰이는 FC-BGA(플립칩-볼그리드어레이)와 동일하다. 단지 기판 가운데 중심축을 담당하는 코어가 ‘FR4’에서 유리인 TGV 기판으로 대체된다.
앱솔릭스는 TGV 공정을 에프앤에스전자에 100% 외주화하므로 미국 코빙턴에 건설한 글래스 코어기판 생산라인에서는 ABF를 이용한 빌드업 공정 개발에 주력하고 있다.
최근 이 회사는 TGV 기판 위에 ABF를 2층을 쌓아 올리는데 성공했으며, 내년에 6층→9층→12층 순서로 적층수를 높여간다는 목표다. ABF는 패키지 기판의 층과 층 사이에서 절연 역할을 담당하는 소재다. ABF를 높이 쌓아 올릴수록 더 고성능의 반도체를 탑재할 수 있다. 삼성전기 등 기존 패키지 기판 회사들이 공급하는 FC-BGA 기판의 최다 적층수는 20층을 넘나들기도 한다.
따라서 이번에 앱솔릭스가 성공했다는 2단 적층은 향후 양산까지 가기 위한 이정표 정도로 볼 수 있으며, 당장 반도체 업체들이 글래스 코어기판에 요구하는 규격까지는 갈 길이 멀다.

반도체 업계가 글래스 코어기판을 도입코자 하는 건 대면적화와 미세회로 패턴 구현이 상대적으로 용이해서다. 이는 곧 고성능 반도체를 여러개 실장하기 위해 글래스 코어기판을 쓰겠다는 뜻이며, FR4 기반의 FC-BGA 대비 ABF를 더 높게 쌓아 올려야 할 수도 있다.
ABF를 높게 쌓아 올릴수록 FC-BGA를 구성하는 구리⋅코어와의 열팽창계수 불일치에 따른 ‘휨(Warpage)’ 가능성이 높아진다. 앱솔릭스가 2층 적층에 성공했다고 해서 6층, 12층 적층까지 성공하리라는 보장은 없다.
한 반도체 패키지 산업 전문가는 “삼성전기⋅LG이노텍이 기존 패키지 기판 사업을 통해 ABF 빌드업 공정에 대한 노하우를 쌓아온 것과 달리 앱솔릭스는 ‘제로베이스’에서 사업을 시작했다”며 “앞으로 더 많은 시행착오를 겪을 수 밖에 없다”고 말했다. 앱솔릭스는 당초 코빙턴 공장을 착공하며 2025년 상반기 글래스 코어기판 양산에 돌입하겠다고 발표했다. 최근의 진척 상황을 보면 상반기 내 양산이 쉽지 않은 게 사실이다.
앱솔릭스, TGV 도금 방식 변경 검토
한편 앱솔릭스는 TGV 기판의 도금 방식을 변경하는 방안도 검토하고 있다. TGV 기판 내에 비아홀을 도금하는 방식은 크게 컨포멀(Conformal) 방식과 풀필(Full Fill) 방식으로 나뉜다(<삼성전기는 쓰는 CMP 공정, 앱솔릭스는 안 쓴다> 참조.
전자는 비아홀 벽면을 코팅하는 정도로 구리막을 형성하는 방법이며, 후자는 이름 그대로 홀 내부를 가득 채우는 기술이다. 앱솔릭스는 그동안 TGV 도금을 컨포멀 방식으로 수행해왔으나 이를 풀필 방식으로 변경하는 방안을 추진 중이다.
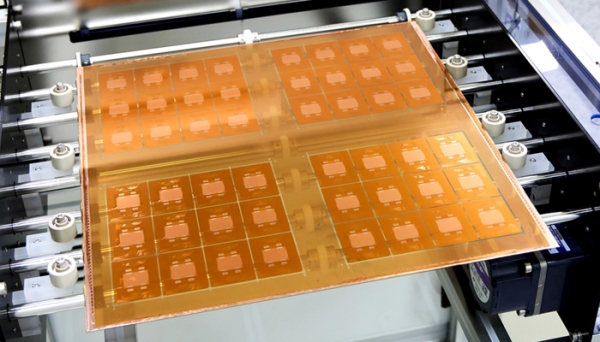
또 다른 반도체 패키지 산업 전문가는 “앱솔릭스가 구리 배선의 저항을 줄이고 유리와의 밀착력을 높이는 측면에서 풀필이 더 유리하다고 판단한 것으로 보인다”고 설명했다.
도금 방식을 풀필로 바꾸면 컨포멀 방식에서는 쓰지 않던 CMP(화학적기계연마) 공정을 도입해야 할 수도 있다. 홀 내부를 구리로 채우는 과정에서 홀 입구가 과도금되는 경우가 많기 때문이다. 이는 CMP를 이용해 평탄화 시켜줘야 한다.

