I/O 밀도 낮은 칩, 값싸게 패키지 하는 기술
FO-PLP 적용하는 대상 변경한 듯
삼성전자가 FO-PLP(팬아웃-패널레벨패키지) 공정 순서를 ‘칩 라스트(Chip Last)’ 방식에서 ‘칩 퍼스트(Chip First)’ 방식으로 전환한다. FO-PLP는 PCB(인쇄회로기판) 일종인 패키지 서브스트레이트가 필요 없어 얇은 패키지를 만들 수 있는 기술이다.
삼성전자와 삼성전기는 TSMC의 FO-WLP(팬아웃-웨이퍼레벨패키지)에 대항하기 위해 FO-PLP 공동개발을 시작했으나 지난 2019년 관련 사업을 삼성전자가 인수한 바 있다.

삼성전자, FO-PLP 칩 퍼스트 방식으로 변경
26일 이 사안에 정통한 관계자는 “삼성전자가 기존 고수하던 칩 라스트 방식을 버리고 칩 퍼스트 방식으로 FO-PLP 공정을 변경했다”며 “칩 퍼스트 공정 양산 시점은 오는 2025년으로 잡고 있다”고 말했다. 삼성전자는 칩 퍼스트 방식으로 FO-PLP 공정을 재개발하기 위한 프로젝트팀을 지난해 9월쯤 결성했다.
FO-PLP와 FO-WLP 등 팬아웃 패키지는 ▲반도체 다이(칩)를 몰딩 위에 붙여 놓고 그 위로 RDL(재배선층)을 올리는 칩 퍼스트 방식과 ▲RDL을 먼저 만든 뒤 그 위에 다이를 붙이는 칩 라스트 방식으로 나뉜다. 적층 구조를 만드는 과정에서 반도체 다이를 가장 먼저 놓느냐(퍼스트), 가장 나중에 놓느냐(라스트)에 따라 갈래가 나뉘는 것이다.
일부에서는 RDL을 기준으로 ‘RDL 퍼스트(=칩 라스트)’, ‘RDL 라스트(=칩 퍼스트)’로 부르기도 하지만 결국은 같은 의미다.
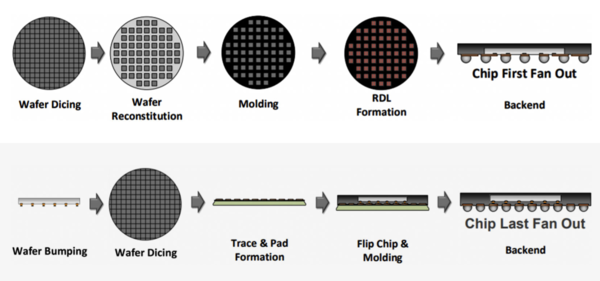
삼성전자가 기존에 개발해 온 칩 라스트는 상대적으로 높은 I/O(인풋/아웃풋) 밀도를 형성할 수 있는 기술이다. 칩이 없는 상태에서 RDL을 먼저 만들기에 공정 중에 칩 패드와 RDL 간의 정렬이 틀어질 위험이 적기 때문이다. RDL을 만든 후 검사 공정을 거치므로 불량 RDL 위에는 칩을 올리지 않을 수도 있다. 불량 RDL 위에 양품 칩을 올리는 위험을 제거할 수 있는 것이다.
이에 비해 삼성전자가 새로 개발하는 칩 퍼스트는 비교적 낮은 I/O 밀도를 가진 반도체를 값싸게 패키지할 수 있는 방식이다. 먼저 잘려진 개별 칩을 몰딩해 놓고, 그 위로 RDL을 포메이션하는 순서로 공정이 진행된다. RDL 포메이션 과정에서 몰딩이나 기판이 열에 의해 휘기 때문에 칩 패드와 RDL 간의 정렬이 틀어질 위험이 크다. 따라서 I/O 밀도가 높은 칩에는 적용하기 어렵다. 양품 칩을 몰딩에 빈틈 없이 깔아 놓고 그 위로 RDL이 올라가는 탓에 RDL 불량이 나면 칩 역시 버려야 하는 것도 단점이다.
삼성전자가 FO-PLP 기술을 칩 퍼스트 방식으로 전환했다는 것은 적용 목표를 고밀도 I/O 반도체에서 저밀도 I/O 반도체로 변경했다는 의미로 풀이된다. 한 반도체 산업 전문가는 “칩 퍼스트 공정은 I/O 밀도만 높지 않으면 비교적 값싸게 반도체를 패키지 할 수 있다”며 “AP(애플리케이션프로세서)처럼 복잡한 구조는 어렵겠지만 PMIC(전력관리반도체) 등을 패키지하는데는 유리할 것”이라고 말했다.

FO-WLP와 역할 나눌듯
삼성전자-삼성전기가 지난 2016년 FO-PLP 프로젝트를 출범했던 건 대만 TSMC에 빼앗긴 애플 AP 위탁생산 물량을 되찾아오기 위해서였다. TSMC는 이전까지 삼성전자 파운드리 사업부가 생산해 온 ‘A시리즈’ AP 생산물량을 2016년부터 전량 도맡았는데, 이는 FO-WLP 상용화가 결정적이었다.
이에 삼성은 FO-WLP보다 더 넓은 지지기판 위에서 생산되는 FO-PLP 공정 개발을 추진했다. 이 프로젝트는 권오현 당시 DS총괄 부회장(현 서울대학교 이사장)이 힘을 실어 줌으로써 탄력을 받았다. 그러나 기대만큼 수율 확보가 되지 않고, 2018년 DS부문장이 김기남 부회장으로 교체되면서 프로젝트가 추진 동력을 잃었다.
최근 삼성전자는 FO-PLP와 별개로 TSMC의 FO-WLP 기술 역시 ‘투 트랙’으로 개발하고 있다. 향후 I/O 밀도가 낮은 저가칩을 FO-PLP로, 하이엔드급 반도체는 FO-WLP 기술을 이용해 패키지 하게 될 것으로 예상된다.
또 다른 반도체 산업 전문가는 “FO-PLP는 이론적으로는 FO-WLP 대비 생산성이 높지만, 이는 양산 수율이 안정적이라는 가정 하에 타당하다”며 “차라리 처음부터 TSMC의 FO-WLP를 팔로업했으면 개발 기간을 절감할 수 있었을 것”이라고 말했다.

