인건비 비중 높은 패키지 라인, 동아시아 중심 성장
메모리 중심의 이기종 패키지 비즈니스 전개 전망
국내와 중국을 거점으로 생산 라인을 운영해온 SK하이닉스가 첫 미국 공장 건설에 나선다. 삼성전자가 파운드리를 앞세워 미국 현지 생산체제를 갖춰왔지만, 메모리 사업 비중이 절대적인 SK하이닉스는 미국 진출 명분이 다소 부족했다.
고객과의 접점이 중요한 파운드리 사업과 달리, 메모리는 조금이라도 더 싸게 생산하는 게 우선이다. 관련 산업이 한국⋅중국⋅일본⋅대만 등 동아시아를 중심으로 발전해 온 이유다. 특히나 이번에 SK가 미국에 짓기로 패키지(후공정)는 팹 대비 인건비 비중이 훨씬 높다는 점에서 향후 SK하이닉스의 행보에 관심이 쏠린다.

인건비 비싼 미국에 짓는 패키지 공장
미국 로이터통신은 12일(현지시간) 복수의 소식통을 인용, SK하이닉스가 내년 1분기 미국 내 패키지 공장 건설에 돌입한다고 보도했다. 공장은 2025~2026년 양산에 돌입하며, 이를 위해 SK하이닉스는 곧 부지선정 작업에 착수할 것이라고 설명했다.
앞서 지난달 26일 최태원 SK 회장은 조 바이든 미국 대통령과의 화상 면담을 갖고, 미국에 220억달러(약 29조원)를 투자하겠다고 밝혔다. 투자금액 중 150억달러는 SK하이닉스가 미국 내 첨단패키지(Advnaced Packaging) 제조 및 연구개발 시설을 마련하는데 쓸 예정이다.
사실 최태원 회장의 발표 이전에도 반도체 업계는 SK하이닉스가 미국에 생산라인을 지을 가능성이 높다고 봤다. 글로벌 반도체 업체들이 앞다퉈 미국 내 반도체 공장을 확장하는 상황에서 계속 중국(우시)에만 해외 공장을 집중하기에는 정치적 부담이 커서다.
SK하이닉스는 우시 공장의 지속적인 설비 투자를 위해 미국 측의 협조가 반드시 필요하다. 앞으로 우시 공장에서도 10세대급 4세대(1a 나노) D램 이상을 생산하려면 EUV(극자외선) 노광 장비 반입이 선행돼야 한다. 그러나 최근 미중 반도체 산업 힘겨루기가 격화하면서 EUV는 고사하고 어플라이드머티어리얼즈⋅램리서치⋅KLA 등이 공급하는 일반 팹 장비 반입마저 중국 반입이 어려워질 처지에 놓였다.

향후 중국 내 반도체 장비 반입 금지 조치가 시행되면 일부 예외라도 허용받기 위해서는 미국 정가를 우군으로 끌어들여야 한다. 이번 220억달러 투자 패키지는 그 사전작업이라는 설명이다. 한 반도체 장비 업체 임원은 “SK하이닉스가 미국에 공장을 짓는다고 해서 중국으로의 장비 반입 예외를 허용받을지 확언할 수는 없지만, 중국에 ‘올인’한 상황보다는 재고할 여지가 생긴다”고 말했다.
다만 업계는 미국 내 인건비 상황을 감안했을 때, 생산라인은 D램 팹이 될 것으로 예상했다. SK하이닉스 생산품목을 놓고 보면 그나마 D램 전공정이 인건비 비중이 가장 낮아 사업성을 확보하기 수월하다. 경영컨설팅업체 맥킨지앤드컴퍼니에 따르면 300㎜ 팹의 직간접 인건비 비중은 전체 비용의 20% 정도다. 200㎜ 팹이나 패키지의 30%에 비하면 낮은 편이다. 파운드리 사업 기반이 약한 SK하이닉스 입장에서는 300㎜ 웨이퍼를 기반으로 한 D램 팹 건설이 그나마 가장 비용 효율적이라는 뜻이다.

FO-WLP 통한 이기종 패키지 시도
따라서 미국 진출 일성으로 패키지 공장을 짓겠다는 SK하이닉스의 발표에 업계는 다소 의외라는 반응이다. D램 팹도 동아시아 대비 미국에서의 사업성이 떨어지는데, 인건비 비중이 큰 패키지라면 말할 것도 없다. 한 글로벌 반도체 후공정 업체 임원은 “특히나 메모리 반도체를 위한 후공정은 파운드리 후공정보다 부가가치가 더 떨어진다”며 “ASE⋅앰코 같은 선두권 패키지 업체들 생산라인이 중국⋅대만에 몰려 있는 이유”라고 말했다.
다만 SK가 투자 발표와 함께 제시한 첨단패키지라는 키워드에서 향후 SK하이닉스의 행보를 읽을 수는 있다. 첨단패키지라는 용어는 통일된 개념이 있는 것은 아니지만 대체로 TSV(Through Silicon Via)와 WLCSP(웨이퍼레벨칩스케일패키지) 등 최신 패키지 기술이 적용된 제품을 뜻한다.
TSV는 HBM(고대역폭메모리)처럼 여러장의 D램을 적층할 때, 아래위 셀 간의 신호전달을 위해 수직 통로를 만드는 기술이다.
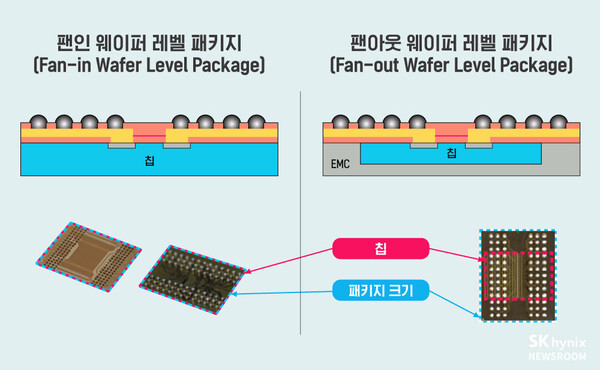
WLCSP는 입출력 솔더볼 위치에 따라 다시 FI-WLP(팬인웨이퍼레벨패키지)와 FO-WLP(팬아웃웨이퍼레벨패키지)로 나뉜다. 이 중에 SK하이닉스가 주목하는 첨단패키지는 FO-WLP다. FO-WLP는 패키지를 위한 별도의 기판(PCB, 인쇄회로기판)이 필요가 없고, 이종 칩간의 수평 연결이 가능해 서로 다른 칩을 하나의 패키지에 실장할 수 있다.
메모리 반도체를 위한 패키지는 물론이고, 프로세서와 메모리를 하나의 패키지 안에 담을 수 있다는 뜻이다. 최근 AI(인공지능) 반도체를 표방하는 xPU칩들은 신호전달 거리를 줄이기 위해 메모리와의 실장 거리를 최대한 단축한다. FO-WLP를 이용해 한 번에 패키지하면 프로세서와 메모리 간의 병목현상을 최소화 할 수 있다.
현재는 파운드리를 중심으로 프로세서와 메모리를 한번에 패키지하는 게 일반적이지만, 앞으로는 SK하이닉스 같은 메모리 회사가 주축이 돼 FO-WLP를 제공할 수도 있다. 이를 위해서는 프로세서 전문 업체들과의 원활한 소통이 필수며, 미국은 해당 산업의 중심지다.
한 반도체 설계 업체 전문가는 “SK하이닉스의 미국 패키지 공장은 이기종 반도체 패키지를 위한 시설”이라며 “앞으로 미국 내 AI 반도체 업체들과의 협업을 통해 메모리를 중심으로 한 패키지 비즈니스를 전개할 것”으로 예상했다.

