노광기 안정화는 물론 필수 부품·소재 개발 더뎌… 다른 광원 연구개발도

▲삼성전자 화성캠퍼스 극자외선(EUV)라인 조감도./삼성전자
극자외선(EUV) 노광 시대가 코앞으로 다가왔다.
삼성전자는 연말, TSMC는 내년 각각 EUV를 활용한 2세대 7나노(㎚) 반도체를 생산하기 시작한다.
아직 펠리클과 포토레지스트(PR) 등 남은 과제가 산적해있는 가운데 EUV의 현재와 업계가 그리고 있는 앞으로의 미래를 짚어본다.
EUV의 현재 - 노광기는 얼추… 필수 부품·소재는 아직
지난해 초까지만 해도 EUV를 조만간 양산라인에 도입할 수 있을 것이라곤 그 누구도 예상치 못했다. 당시까지 개발된 EUV 노광기의 처리량(Throughput)이 기존 액침 불화아르곤(ArFi) 노광기의 4분의1도 되지 않았기 때문이다. 액침 불화아르곤 노광기는 시간당 275장의 웨이퍼를 처리한다.
작년 7월, ASML이 소스 출력을 250W(정확히는 246W)로 늘린 ‘NXE:3400B’를 선보이면서 얘기가 달라졌다. 양산용으로 출시된 ‘NXE:3400B’는 시간당 웨이퍼 125장을 처리할 수 있다.
액침 불화아르곤 노광기 처리량의 절반도 되지 않지만 전체 반도체 전체 레이어(Layer)의 일부에 불과한 1~3개만 처리한다는 점을 감안하면 양산이 불가능한 정도는 아니다.
하지만 EUV 상용화의 과제는 아직 많다.
먼저 EUV 노광기는 아직 안정화되지 않았다. 업계에 따르면 현재 EUV 양산 설비의 가동시간은 70~80%에 불과하다. 1시간 가동하면 42~48분 정도만 정상 작동한다는 뜻이다. 양산에 돌입하려면 90% 이상의 가용성을 확보해야한다.
업계 관계자는 “연말까지 ASML이 90% 근사치로 가용성을 높일 계획이라고 발표했다”며 “이 때문에 삼성전자가 연내 7나노 양산을 시작하더라도 생산량을 늘리는 데는 한계가 있을 것이라고 본다”고 말했다.
펠리클과 PR, 그리고 마스크 등 EUV 노광 공정에 필요한 부품들도 아직 개발되지 않았다.

▲EUV 노광기 내부의 작동 과정. 광원에서 나오는 빛이 상단에 위치한 펠리클을 거쳐 마스크에 도달하고, 반사돼 웨이퍼에 쪼여진다./마이크로일렉트릭엔지니어링, KIPOST 재구성
EUV 노광 공정은 노광기에서 나오는 빛을 마스크에 반사시켜 웨이퍼에 쪼이고, 웨이퍼 위 PR이 빛에 반응하면서 움푹 패이거나 남아있는 과정을 거쳐 진행된다.
마스크에 눈에 보이지 않는 정도로 작은 먼지(Particle)만 껴도 웨이퍼에 정확한 회로도가 그려지지 않는다. 펠리클은 이 마스크의 보호막 역할을 하는데, 소재의 빛 투과율이 높아야 더 큰 크기의 빛을 전달해 정확히 패터닝을 할 수 있다.
이에 업계는 폴리머 필름 대신 폴리실리콘 재질의 펠리클을 개발하고 있다. 선두는 ASML로, 아직 업계가 요구하는 빛 투과율 95%를 달성하지 못하고 있다. EUV 광원으로부터 나오는 열을 견딜 수 있어야하고 생산성도 높아야하는 등 다양한 요구 사항을 충족해야하기 때문이다.
ASML에 따르면 현재 회사가 개발한 펠리클은 빛 투과율 83%에 250W 출력까지 버틸 수 있다. 하지만 3000장의 웨이퍼를 처리하고 나면 교체해야한다. ASML의 다음 목표는 최대 300W의 출력을 견딜 수 있고 88%의 투과율을 낼 수 있는 펠리클로, 1만장의 웨이퍼를 감당할 수 있는 제품이다.
펠리클이 없어도 1~2개의 레이어 정도는 처리할 수 있지만 추가 검사 과정이 필요하다. 더 많은 레이어에 EUV를 쓰기 위해선 펠리클 사용이 불가피하다. 펠리클 없이는 장당 5억원 정도의 마스크 손실을 감당하기 힘들기 때문이다.
펠리클 없이 7나노 2세대(7LPP) 공정을 가동할 계획인 삼성전자 또한 자체적으로 펠리클을 연구개발(R&D) 중이다.
EUV의 빛에 반응, 패턴을 직접 형성하는 PR 또한 아직 완성되지 않았다. 빛은 광자들의 집합이다. 광원에 가까울수록 빛이 세지는 것처럼 광자 또한 영역에 따라 개수가 다르다.
EUV 광원은 여러 거울을 거치기 때문에 실질적으로 웨이퍼에 조사되는 광자의 양은 많지 않다. 이를 검출하기 위해선 PR의 감도를 높여야하는데, 애초에 광자의 양이 많지 않다보니 영역에 따라 반응하는 정도가 달라져 패턴에 결함이 생긴다. 이를 확률론적 결함이라고 한다. 그렇다고 반응속도를 늦춰 균일도를 높이기도 어렵다.
감도와 확률론적 결함 및 처리량이 서로 상보적인 관계인 이유다. 업계는 PR의 양 자체를 늘려 두 변수의 상보적 관계를 개선하는 쪽으로 PR을 발전시켜왔지만 현재는 당초 목표량의 2배 두께로 PR을 입혀야한다. 풍선효과처럼 이 두께를 줄여야하는 문제에 부딪힌 셈이다.
마스크 난이도도 높아졌다. 삼성전자는 블랭크마스크를 가져다 EUV 노광용 마스크를 직접 설계, 제작한다. 설계도만 넘겨 마스크 업체가 생산하던 이전과 다른 결정이다.
현재 블랭크마스크는 유리 기판에 불투명한 크롬층을 입혀 만들지만, EUV 마스크는 실리콘과 몰리브덴을 40~50층 겹쳐서 250~350나노 두께로 제작돼 각 층이 거울처럼 작동한다. 미립자 등 미세한 결함조차 용납되지 않는 이유다.
업계는 결함(Defect) 수준을 한자릿수로 낮췄지만, 아직 결함을 완전히 해소하진 못했다.
블랭크마스크에 패턴을 입히는 전자빔(E-beam) 마스크 제작기(writer)도 처리량을 늘려야한다는 요구가 일고 있다.
패턴이 복잡해지면서 가변 모양 빔(VSB) 기술에 기반한 단일 광원 기기로 그리려면 오랜 시간이 필요하기 때문이다. 고밀도 레이어를 그릴 때는 30시간 이상이 걸린다. 업계는 이에 멀티 빔 마스크 제작기를 개발 중이다.
광학 및 전자빔 기반 마스크 검사 장비도 아직이다. 해상도를 높이는 데 한계가 있고 불투명한 펠리클을 씌운 다음에는 마스크를 검사할 수 없기 때문이다. 이에 업계는 화학적(Actinic) 마스크 검사 장비를 개발하고 있고, ASML은 검사시에는 펠리클이 자동으로 올려지고, 작업이 완료되면 다시 제자리로 돌아가는 방식으로 개발 중이다.
EUV의 미래, 개구수(NA)는 높이고 공정변수(K1)는 낮춰라
노광기의 해상도는 공정변수(K1·공정 복잡도를 수치화한 수치)와 광원 파장(λ)에 비례하고, 개구수(NA)에 반비례한다. NA는 렌즈를 거쳐 굴절되지 않고 실제 입사되는 빛의 양을 결정하는 수치로 렌즈의 굴절률과 빛이 입사하는 각도에 따라 달라지는데 보통 렌즈 크기를 키워 낮춘다.
ASML은 K1 값은 높이고, NA 값은 줄이는 방향으로 EUV 로드맵을 세웠다.
내년 오버레이(각 층의 정렬 상태) 및 초점 개선 패키지(OFP)로 오버레이 정확도(matched overlay)을 2.0나노에서 1.7나노로 높이고 내부 웨이퍼 교체·운송 시스템을 개선해 처리량을 145장 이상으로 늘릴 계획이다.
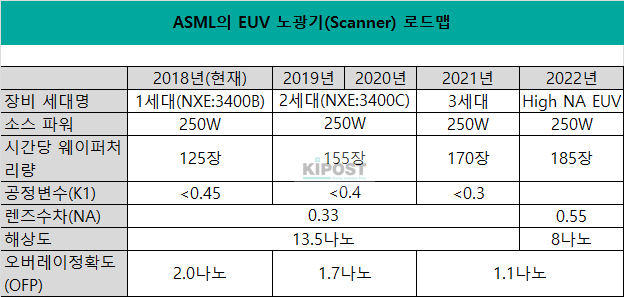
▲ASML의 EUV 노광기 로드맵./ASML, KIPOST 재구성
내년 말 출하할 계획인 2세대 ‘NXE:3400C’는 시간당 155장 이상의 웨이퍼를 처리할 수 있도록 생산성을 개선한다. 1세대의 K1 값이 7나노 기준 최대 0.45였다면, 2세대는 이를 0.4이하로 낮출 계획이다. 더블 패터닝을 구현하려면 이를 0.28 이하로 줄여야한다.
ASML은 2021년 K1 값을 0.3 이하로 줄이고, 시간당 처리량을 170장으로 늘린 3세대 EUV 노광기를 출시하는 한편, NA값을 0.33에서 0.55로 높인 차세대 EUV 플랫폼을 선보일 계획이다.
NA가 높아지면 해상력이 높아져 미세 패턴 형성에 유리하다. 일명 ‘High NA’ EUV 플랫폼으로 알려진 이 노광기는 시간당 185장의 웨이퍼를 처리하고, 오버레이 정확도는 1.1나노로 해상도를 8나노까지 높일 수 있다.
EUV 이후 차세대 노광 기술은 무엇이 될까. ASML은 2020년대 중반쯤 소스 출력을 높여 오는 2030년까지는 ‘High-NA’ EUV 플랫폼이 노광 기술의 주류가 돼 1나노 미만의 반도체도 만들 수 있을 것이라 내다본다.
하지만 NA 값을 0.5 이상으로 높이면 생태계는 그대로 유지할 수는 있지만, 렌즈 크기가 그만큼 커져야해 장비 가격이 현재의 2배에 달할 것으로 업계는 내다본다. 대당 3000~4000억원을 호가할 것이란 뜻이다. 생산 공장(Fab) 크기도 키워야한다.
이에 업계와 학계는 빛 파장을 EUV의 13.5나노에서 EUV와 X선(0.01나노~10나노) 사이 파장대를 가진 일명 ‘블루-X’로 바꾸는 것을 연구하고 있다. ‘블루-X’의 광원은 레이저생성플라즈마(LPP), 탄소 레이저, 마이크로 레이저, 워터 윈도우(Water Window) 등이 있다.
업계 관계자는 “전력소모량이나 반사율 등은 개선해야하지만 상용화가 되면 장비 가격을 낮출 수 있다”며 “현재는 1~3장에 EUV를 도입한 미세 패턴이 필요하지만, 다수의 레이어가 미세 패터닝을 필요로 하는 때가 오면 충분한 이점을 가질 수 있다”고 말했다.

