기존 HBM3 8H(8단 적층)대비 성능과 용량 모두 50% 이상 향상
'Advanced TC NCF' 기술 활용해 8단과 동일한 높이로 12단 적층 구현
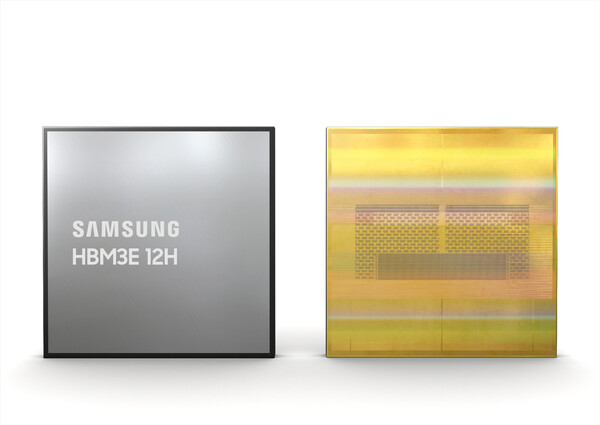
삼성전자가 업계 최초로 36GB(기가바이트) HBM3E(5세대 HBM) 12H(High, 12단 적층) D램 개발에 성공하고 고용량 HBM 시장 선점에 나선다고 27일 밝혔다.
삼성전자는 24Gb(기가비트) D램 칩을 TSV(Through-Silicon Via, 실리콘 관통 전극) 기술로 12단까지 적층해 업계 최대 용량인 36GB HBM3E 12H를 구현했다.
HBM3E 12H는 초당 최대 1,280GB의 대역폭과 현존 최대 용량인 36GB을 제공해 성능과 용량 모두 전작인 HBM3(4세대 HBM) 8H(8단 적층) 대비 50% 이상 개선된 제품이다. HBM3E 12H는 1,024개의 입출력 통로(I/O)에서 초당 최대 10Gb를 속도를 지원한다. 초당 1,280GB를 처리할 수 있어 1초에 30GB 용량의 UHD 영화 40여편을 업(다운)로드 할 수 있는 속도를 구현한다.
삼성전자는 'Advanced TC NCF'(Thermal Compression Non Conductive Film, 열압착 비전도성 접착 필름) 기술로 12H 제품을 8H 제품과 동일한 높이로 구현해 HBM 패키지 규격을 만족시켰다.
'Advanced TC NCF' 기술을 적용하면 HBM 적층수가 증가하고, 칩 두께가 얇아지면서 발생할 수 있는 '휘어짐 현상'을 최소화 할 수 있는 장점이 있어 고단 적층 확장에 유리하다.
삼성전자는 NCF 소재 두께도 지속적으로 낮춤으로써 업계 최소 칩간 간격인 '7마이크로미터(um)'를 구현했다. 이를 통해 HBM3 8H 대비 20% 이상 향상된 수직 집적도를 실현했다.
특히 칩과 칩사이를 접합하는 공정에서 신호 특성이 필요한 곳은 작은 범프를 열 방출 특성이 필요한 곳에는 큰 범프를 목적에 맞게 사이즈를 맞춰 적용했다. 크기가 다른 범프 적용을 통해 열 특성을 강화하는 동시에 수율도 극대화했다.
또 삼성전자는 NCF로 코팅하고 칩을 접합해 범프 사이즈를 다양하게 하면서 동시에 공극(Void)없이 적층하는 업계 최고 수준의 기술력도 선보였다.
삼성전자가 개발에 성공한 HBM3E 12H는 AI 서비스의 고도화로 데이터 처리량이 급증하는 상황 속에서 AI 플랫폼을 활용하는 다양한 기업들에게 최고의 솔루션이 될 것으로 기대된다.
특히 성능과 용량이 증가한 이번 제품을 사용할 경우 GPU 사용량이 줄어 기업들이 총 소유 비용(TCO, Total Cost of Ownership)을 절감할 수 있는 등 리소스 관리를 유연하게 할 수 있는 것도 큰 장점이다
예를 들어 서버 시스템에 HBM3E 12H를 적용하면 HBM3 8H를 탑재할 때 보다 평균 34% AI 학습 훈련 속도 향상이 가능하며, 추론의 경우에는 최대 11.5배 많은 AI 사용자 서비스가 가능할 것으로 기대된다.
삼성전자는 HBM3E 12H의 샘플을 고객사에게 제공하기 시작했으며 상반기 양산할 예정이다.

