IEEE, 이기종통합로드맵(HIR) 1.0 버전 발표… 소재부터 패키지 형태까지
시스템인패키지(SiP), 안테나인패키지(AiP), 폴리이미드(PI) 및 유리 기판 등
세계전기전자기술자학회(IEEE)가 최근 반도체 후공정 기술 로드맵인 ‘이기종 통합 로드맵(HIR)’ 1.0버전을 완성했다.
지난 2016년 국제반도체기술로드맵(ITRS) 발표가 중단된 이후 업계 차원에서 후공정 기술 로드맵이 나온 건 이번이 처음이다.
HIR에는 2차원(2D)에서 2.5D, 3D, 이기종 통합(Heterogeneous Integration)으로 이어지는 중장기 미래 청사진이 담겼다. ‘미세화’에만 초점을 맞춘 전공정 기술 발전과 달리, 전방 산업과 반도체 종류, 기술에 따라 로드맵을 세분화했다.
특히 주목되는 건 5세대 이동통신(5G) 반도체 패키지 로드맵이다. 주파수 대역이 높아지고 30개 이상의 대역을 지원해야해 소재부터 패키지 형태까지 바뀌지 않는 게 없다.
시스템인패키지(SiP)의 확대 적용
이전까지 후공정 업계는 무선통신(RF) 부품 중 모뎀을 가장 수익성이 높은 제품으로 꼽았다. 5G 이동통신부터 또다른 먹거리로 등장한 게 시스템인패키지(SiP) 기술이 적용되는 RF 프론트엔드모듈(FEM)이다.
5G는 24㎓ 이상 밀리미터파(mmWAVE) 대역을 활용한다. 대역이 높아지면 파장이 짧아지는데, RF 부품이나 안테나 같은 요소간 거리가 반파장 값보다 크면 신호가 제대로 전달되지 않는다. 우리나라에서 활용하는 5G 대역인 28㎓ 기준 반파장 값은 5.35㎜다.
4G RF FEM은 안테나, 모뎀과 별도로 탑재됐고 패키지 기술로는 플립칩(FC)이나 팬아웃 웨이퍼레벨패키지(FoWLP)를 활용했다. 스마트폰보다 공간 제한에서 자유로운 기지국 장비에는 RF FEM에 들어가는 각 구성요소가 별도 적용됐다.

하지만 5G 기지국에 적용되는 다중입출력(MIMO) 안테나 어레이(Array)는 최대 256개의 안테나가 화장실 타일처럼 5㎜ 간격으로 다닥다닥 붙어있어야 한다.
각 안테나에는 빔포빙(Beamforming) 기능을 제어하는 빔포머 컨트롤러 집적회로(IC)가 하나씩 붙는다. 신호 손실을 막기 위해 별도로 들어가던 전력증폭기(PA) 및 저잡음증폭기(LNA), 필터 등도 RF FEM으로 묶였다.
PA와 RF 스위치는 질화갈륨(GaN), 갈륨아세나이드(GaAs), 실리콘게르마늄(SiGe) 등 실리콘(Si) 대비 스위칭 속도가 빠르고 손실이 적은 Ⅲ-Ⅴ족 화합물로 만들어진다.
입출력(I/O) 숫자가 늘어나면서 모뎀 패키지 라인앤드스페이스(L/S) 요구사항도 점점 늘어난다. L/S는 패키지 미세화의 기준이다. 5G 모뎀의 L/S 요구사항은 현재 5/5㎛에서 5년 후인 2025년 현재의 고성능 AP 수준인 2/2㎛, 2030년에는 1/1㎛로 강화될 전망이다.
반도체 후공정 업계 관계자는 “5G 안테나는 빔포밍(Beamforming)을 제어하는 빔포머 컨트롤러를 어레이에 하나하나 붙이는데, 이 IC 사이 거리가 2~3㎜에 불과하다”며 “조금만 틀어져도 빔포밍 기술 구현이 어려워 패키지부터 조립까지 쉬운 일이 아니다”라고 말했다.
이기종 통합 기술 ‘안테나 인 패키지(AiP)’... 안테나 온 칩(AoC)은 6G에
4G 때까지만 해도 안테나는 인쇄회로기판(PCB)에 내장돼 칩과 연결됐다. mmWAVE를 지원하는 5G 스마트폰을 들여다보면 RF FEM에 안테나가 결합된 ‘안테나 인 패키지(AiP)’를 찾아볼 수 있다. 안테나에서 넘어오는 신호 손실을 최소화하기 위한 선택이다.
상용화는 됐지만 AiP에도 도전과제가 있다. 5G 로드맵상 갈수록 주파수 대역이 높아지기 때문에 이에 따른 대응을 해야한다.
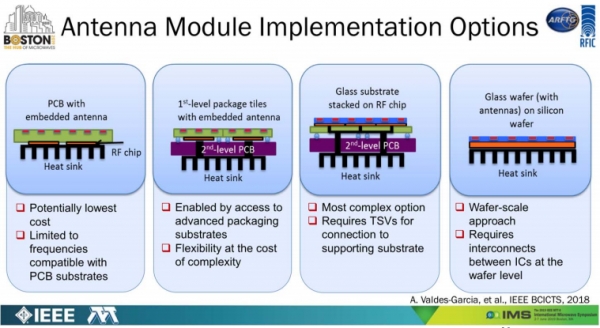
특히 기판의 두께가 발목을 잡는다. 기판의 두께가 두꺼울수록 신호 손실이 커진다. 내후년 발표될 5G 3차 표준(Rel. 17)에서는 28㎓는 물론 52.6㎓, 60㎓ 대역 서비스 등도 포함된다. 28㎓ 대역에서 AiP 기판 두께는 1.6㎜ 였지만, 60㎓에서는 이보다 4분의1을 줄여야 손실을 막을 수 있다.
기판이 얇아지면 휨(Warpage) 현상 등이 발생할 뿐더러 조그만 진동에도 취약해 안테나 어레이를 정확히 칩 위에 올려놓기 어렵다.
이에 TSMC와 인텔은 접근 방향을 바꿨다. TSMC는 RF칩에 안테나 어레이를 올리는 대신, RF칩을 몰딩 재료로 덮고 재배선층(RDL)으로 슬롯 커플드(Slot-Coupled) 안테나를 구현한 ‘InFO-AiP’ 솔루션을 개발했다. RF칩은 기판과 RDL로 연결, 신호 전송 경로를 최대한 줄였다. 인텔은 안테나 어레이에 기판을 올리고 RF 칩을 붙이는 방법을 택했다.
AiP와 함께 거론되는 게 RF FEM과 모뎀, 안테나 등을 모두 하나의 패키지에 담는 안테나 온 칩(AoC)이다. AoC는 크기를 최소화할 수 있다는 장점이 있지만 RF 신호가 집중돼 방사선이 안테나를 통해 삐져나온다.
여기에 실리콘 기판의 높은 유전율과 낮은 저항 때문에 기판 재료에 대한 연구개발(R&D)이 필요하다. AiP는 실리콘 기판에 만들어진 칩을 다른 기판에 옮겨서 패키지하는 개념이라 기판 선택이 보다 자유롭다.
당장 5G에서는 AiP가 메인이지만, 그 이후 6G에서는 AoC가 매력적인 솔루션이 될 것으로 IEEE는 전망했다.
유리 기판? 떠오르는 PI 기판
5G RF 부품이 내장되는 기판은 반도체와 열팽창계수(CTE)가 맞아떨어져야 한다. 신호 손실을 줄이기 위해 유전율도, 저항도 낮아야 한다. 유력하게 검토되던 건 저온동시소성세라믹(LTCC), 저유전 FR4, 액정폴리머(LCP), 폴리이미드(PI), 유리, 실리콘 등이다.

열팽창계수에서는 웨이퍼의 소재이기도 한 실리콘이 독보적이다. 나머지는 CTE 차이가 커 솔더 접합 신뢰성을 확보해야하고 부가적으로 언더필(Underfill)을 써야한다.
FR4는 유전율과 저항, 손실값이 커 28㎓ 이상을 지원하기가 쉽지 않고 LTCC는 성능은 좋으나 워낙 잘 깨져 대량양산이 어렵다. 현재는 대부분 LCP와 저유전 FR4를 활용하지만, 28㎓ 서비스가 본격화되도 FR4가 살아남을지는 미지수다.
단순 성능만 보면 유리가 가장 우수하지만, 가격 탓에 아직 도입한 업체는 없다. 통상 주파수 대역이 올라가면 재료의 유전율도 증가하는데, 유리의 경우 5.8㎓ 대역은 물론 50㎓ 대역에서도 유전상수(Dk) 3.3, 유전손실(Df) 0.0044를 유지한다.
유리 기판은 전도성이 극히 낮기 때문에 유리관통전극(TGV) 기술을 활용, 기판에 구멍을 송송 뚫어 구리를 넣거나 아예 구리 층을 도포해 전기가 통하게 만든다.
유리 기판과 함께 새롭게 떠오르는 게 PI 기판이다. 다우(Dow)는 최근 LCP를 대체할 수 있는 ‘글래스 프리(Glass Free)’ PI 기판을 개발했다. 유전율과 손실값은 유리 에폭시와 비슷한 수준이며, 온도 안정성과 강도는 LCP보다 높다.
이에 IEEE는 28㎓ 이상 대역폭 서비스가 본격화되면 유리 및 PI 기판 채택도 진행될 것이라 내다본다.
후공정 업계 관계자는 “주파수 대역이 높아질수록 소재, 칩 간 배치, 패키지 형태 등이 모두 바뀌는데, 5G는 상용화 도입이 앞당겨져 가까스로 기한에 맞춰 기술 개발을 끝낼 수 있었다”며 “2030년 메인이 될 6G 이동통신은 테라헤르츠 대역인 100㎓~10㎔ 주파수를 활용하는만큼 차근차근 로드맵에 나온 기술을 개발해야한다”고 말했다

