"구미 사업장에 내년 2분기 입고"
LG이노텍이 반도체 패키지용 기판 소재로 쓰이는 FC-BGA(플립칩-볼그리드어레이)용 장비를 발주했다. FC-BGA는 최근 고성능 서버와 PC에서 다양한 반도체들을 2.5D 패키지하는 수요가 늘면서 세계적인 품귀를 겪고 있는 품목이다.
LG이노텍은 그동안 스마트폰 등 모바일 기기에 쓰이는 FC-CSP(플립칩-칩스케일패키지) 기판 사업에 집중해왔으나, 이번에 FC-BGA 사업에 처음 진출하게 됐다.
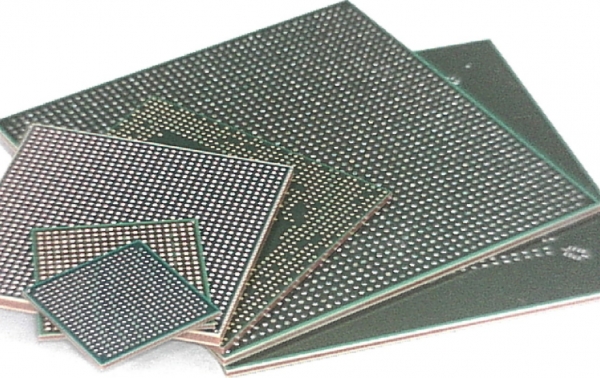
“FC-BGA 설비, 내년 2분기 구미 사업장으로 입고”
8일 한 PCB(인쇄회로기판) 장비업체 임원은 KIPOST에 “LG이노텍이 발주한 FC-BGA 기판 생산 설비가 내년 2분기 경북 구미 사업장으로 입고될 계획”이라고 말했다. LG이노텍은 지난해부터 FC-BGA 사업 진출을 타진했으며, 최근 다수의 장비 업체들에 구매발주(PO)를 냈다.
내년 2분기 생산 설비들이 입고되면 셋업과 안정화 작업을 거쳐 이르면 내년 연말, 혹은 내후년 초 정도에 양산에 돌입할 수 있을 것으로 예상된다.
당초 LG이노텍은 LED(발광다이오드) 사업 철수 후 공간이 비워진 경기도 파주나, 기존 FC-CSP 사업을 영위하던 구미 사업장 두 곳을 FC-BGA 사업 후보지로 검토했다. 최종적으로는 FC-CSP 2공장 인근의 유휴부지를 FC-BGA 공장으로 낙점했다. FC-CSP와 FC-BGA 공장을 인접하게 붙여 놓는 게 인력 운용이나 물류 측면에서 유리할 것으로 판단했다.
LG이노텍이 FC-BGA 라인에 본격 투자하면서 국내 FC-BGA 공급사가 3개로 늘었다. 삼성전기와 대덕전자가 각각 FC-BGA 사업을 영위하고 있다.
다만 LG이노텍이 내년, 혹은 내후년 양산을 시작한다고 해도 당장 하이엔드급 제품 생산에 나설 가능성은 낮다. FC-BGA는 정사각형 형태의 얇은 기판인데, 면적이 넓을수록 부가가치가 높다. 고성능 서버용 반도체 패키지에는 대부분 50㎜ X 50㎜ 이상의 ‘라지 바디(Large Body)’ 제품이 적용된다.

반도체 업계는 2023년까지 FC-BGA 크기가 150㎜ X 150㎜ 수준으로 넓어질 것으로 예상한다. 다양한 종류의 반도체를 한번에 2.5D 방식으로 패키지하기 위해서는 FC-BGA 면적이 넓어야 하기 때문이다.
그러나 최대 20개층 레이어로 구성된 FC-BGA를 큰 면적으로 만들기 위해서는 내부 소재들의 열팽창계수를 맞추는 등 까다로운 작업이 동반된다. 내부 소재간 열팽창계수에 차이가 나면 기판 휨 현상이 발생하면서 불량이 나기 쉽다.
반도체 후공정 업체 임원은 “LG이노텍이 일단 20~30㎜² 안팎의 미들급 제품부터 생산할 것으로 예상된다”며 “생산 경험치를 쌓은 후 50㎜ X 50㎜ 이상 하이엔드 제품으로 확장하는 게 합리적”이라고 말했다.

