FO-WLP, 별도 기판 없이 패키지 완료
당장은 AP 등 하이엔드 제품에 집중
삼성전자가 첨단 패키지 공정 기술인 FO-WLP(팬아웃-웨이퍼레벨패키지) 투자에 나설 것으로 예상되면서 반도체 패키지용 기판(IC Substrate) 업체들도 촉각을 곤두세웠다(KIPOST 2022년 4월 8일자 <삼성전자, FO-WLP에 대규모 투자 막판 고심> 참조).
FO-WLP 공정은 별도 기판을 쓰지 않고도 후공정을 마무리 할 수 있다. FO-WLP로 후공정을 처리하는 양이 늘면 그 만큼 패키지용 기판 시장이 위축될 수 있다.

FO-WLP, 기재는 사라지고 기능만 남긴다
반도체 후공정에서 패키지 기판은 반도체를 외부 충격으로 부터 보호하고, 신호를 메인보드에 전달하는 중간통로 역할이다. FO-WLP는 이 패키지 기판을 밖에서 구입하지 않고, 칩 업체가 반도체 공정 장비를 이용해 직접 형성하는 게 골자다. 충격 보호는 칩을 감싸는 몰딩 소재가, 신호 전달은 RDL(재배선층)이 각각 담당케 한다.
이는 마치 디스플레이 산업에서 터치스크린이 사라지고, 그 기능을 OLED(유기발광다이오드) 위에 패터닝된 금속배선으로 대체하는 것과 유사하다. 필름이라는 기재가 완전히 사라짐으로써 원가를 절감하고, 디스플레이 전체 두께가 얇아질 수 있는 것이다.
FO-WLP를 통해 생산된 패키지는 별도 기판이 사용된 기존 패키지 대비 두께를 50% 가량 줄일 수 있다. 수율이 확보된다는 가정 하에 원가 절감도 가능하다.
이는 전체 반도체 공정 흐름상에서 보면, 칩 업체가 후공정과 패키지용 기판 시장까지 내재화하는 형태가 된다. 이 때문에 반도체 후공정 업계가 촉각을 곤두세울 수 밖에 없는 것이다. 삼성⋅LG디스플레이가 터치스크린 공정을 내재화함으로써 터치필름 시장이 초토화 된 것처럼, FO-WLP 투자 확대는 패키지용 기판 시장에 부정적 신호다.
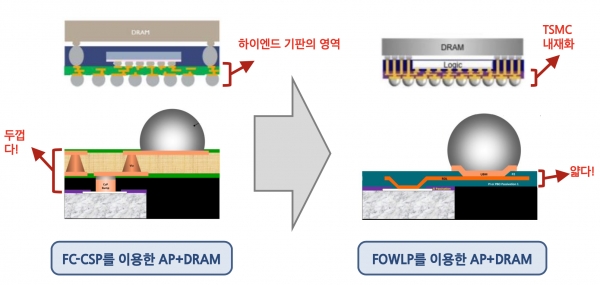
실제 지난 2016년 애플이 ‘아이폰7’ 시리즈에 AP(애플리케이션프로세서)와 D램을 묶어 FO-WLP로 패키지함으로써 패키지 기판 시장에 타격을 준 바 있다. 다만 이번에 투자에 나설 삼성전자의 FO-WLP 타깃이 일단은 하이엔드급 AP에 한정된다는 점에서 단기적으로 줄 영향은 크지 않을 전망이다.
한 반도체 후공정 업체 임원은 “삼성전자가 FO-WLP와 FO-PLP(팬아웃-패널레벨패키지) 중에 FO-WLP로 돌아서게 된 배경도 하이엔드 AP 패키지에 FO-WLP가 더 유리하다고 판단했기 때문”이라고 말했다. 내년 하반기 삼성전자가 FO-WLP 라인을 양산 가동하더라도 일단은 AP 물량 배정에 집중할거란 뜻이다.
스마트폰용 AP는 다른 반도체 대비 두께 축소에 따른 이점이 크다. 스마트폰 완전품 두께를 줄이거나, 줄어든 공간에 방열설계를 추가할 수도 있다. 최근 삼성전자 스마트폰 ‘갤럭시S22’ 시리즈가 발열과 성능저하 이슈가 제기된 점을 감안하면 방열설계 공간을 추가로 확보한다는 의미는 작지 않다.
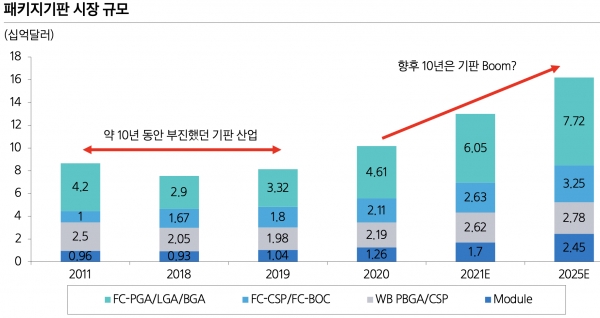
단 향후 생산능력을 확대하는 과정에서 AP 뿐만 아니라 PMIC(전력관리반도체)⋅RF(Radio Frequency) 등으로 적용 범위가 넓어질 가능성을 완전히 배제할 수는 없다. 대만 반도체 후공정업체 스필(SPIL)은 AP와 고성능 컴퓨팅용 반도체 뿐만 아니라 PMIC⋅RF⋅와이파이칩 등 다양한 반도체에 대해 FO-WLP 공정 서비스를 제공한다. 국내 후공정 업체인 네패스는 같은 계열 기술인 FO-PLP를 이용해 PMIC 패키지를 양산한다.
FC-BGA 시장은 여전히 유망
따라서 반도체 패키지 기판 업체 입장에서 FO-WLP 확대에 따른 물량 감소는 장기적으로 거스를 수 없는 추세임에는 분명하다.
최근 반도체 기판 업계가 FC-BGA(플립칩-볼그리드어레이) 기판 생산능력 확대에 사활을 걸고 있는 것도, 이러한 흐름과 무관치 않아 보인다. FC-BGA는 최근의 치플렛(Chiplet) 방식 생산이 일반화 되어 가는 고성능 패키지 산업의 필수 부품이다(KIPOST 2022년 4월 12일자 <"치플렛 방식 생산 확대" 내년에 FC-BGA 부족 사태 더 심각> 참조).
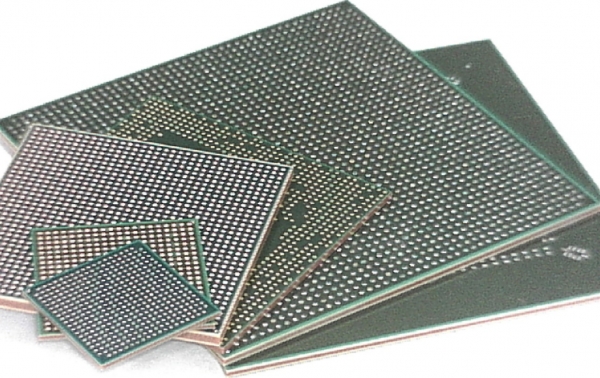
일반 패키지 기판처럼 FO-WLP를 통해 칩 업체가 공정을 내재화해버릴 가능성도 현재는 없다. 한 PCB 업체 임원은 “더 많은 수의 반도체를 실장할수록 FC-BGA 면적은 늘어나는 구조”라며 “적어도 2025년까지 FC-BGA 적용 확대에 따른 과실을 모든 후공정 업계가 공유할 것”이라고 설명했다.

