TSMC의 2.5D 패키지 브랜드명
CoWoS-S, CoWoS-R, CoWoS-L 등 3종류
지난 8일(현지시간) 애플 신제품 발표 이벤트의 백미는 맥용 반도체 M1의 전문가 버전인 ‘M1 울트라’였다. 지난해 10월 출시된 ‘M1 프로’와 ‘M1 맥스’가 이미 전문가급 성능을 보여줬으나, 애플은 이 M1 맥스 2개를 이어 붙여 경쟁사 추격을 불허하는 전성비(전력 대 성능비)를 구현했다.
통상 2개의 칩을 통합한 기존 MCP(멀티칩패키지)는 패키지 기판을 통해 각 칩이 와이어로 상호 연결된다. 서로 데이터를 주고 받을 수 있는 속도가 제한적일 수 밖에 없다. ‘1+1=2’라는 진리가 통하지 않는다.
그러나 M1 울트라는 대만 TSMC의 최신 패키지 기술인 CoWoS(칩온웨이퍼-온서브스트레이트)를 적용, 완벽히 하나의 칩처럼 동작하게 만들었다(KIPOST 2022년 3월 11일자 <애플 'M1 울트라' 칩...TSMC CoWoS-S 패키징 기술 채용> 참조).
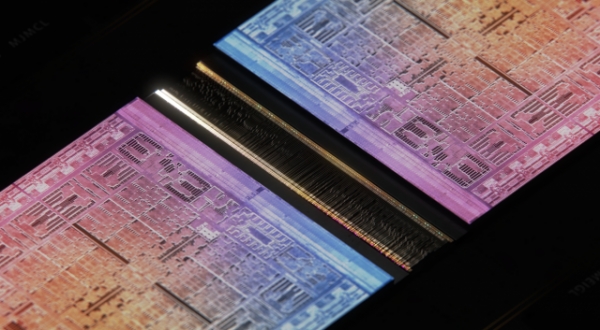
CoWoS, 2개의 칩을 하나의 칩처럼
CoWoS는 2.5D 패키지 기술을 이르는 TSMC의 브랜드명이다. 2개 이상의 반도체 칩을 웨이퍼 상에서 상호 연결한 뒤 패키지 기판에 올린다는 의미로 CoWoS라고 부른다. 따라서 CoWoS 역시 기존 2.5D 패키지 기술의 특성을 그대로 가지고 있다. 2D 패키지처럼 칩이 수평 방향으로 배열되면서도, 3D 패키지와 마찬가지로 속도 제한 없는 상호 연결이 가능하다는 뜻이다.
그 핵심은 각 칩을 마치 하나의 다이처럼 연결해주는 실리콘 인터포저다. 인터포저는 반도체 칩의 일종이지만 어떠한 로직 기능 없이 신호 연결만을 담당하는 게 특징이다. 패키지 기판 대비 미세 회로 구현이 가능해 2.5D 패키지 내에서 각 칩을 연결하는데 사용된다. 다만 대면적으로 갈수록 가격이 비싸다. 두께가 100μm(마이크로미터) 수준으로 얇아 제조상 컨트롤하기도 어렵다.
TSMC는 팬아웃-웨이퍼레벨패키지(FoWLP) 기술에 속하는 ‘InFO’와 함께 CoWoS를 3차원 구조(3D Fabric)로 분류하고 있다. 또 CoWoS 내에서 각 칩을 어떤 방식으로 연결하느냐에 따라 ‘CoWoS-S’, ‘CoWoS-R’, ‘CoWoS-L’ 3 단계로 구분한다.
이번에 TSMC가 애플 M1 울트라 제조에 사용한 기술은 이 중에 CoWoS-S로, 각 칩 연결에 풀사이즈 인터포저만을 사용하는 방식이다. CoWoS-S는 데이터 통신 속도는 가장 빠르지만 대면적 인터포저 탓에 제조단가는 가장 비싸다.

애플의 M1 울트라는 CPU⋅GPU가 10코어⋅32코어인 M1 맥스 2개를 이어 붙여 정확히 두 배씩의 성능을 구현했다. 20코어 CPU, 64코어 GPU로 내장 트랜지스터는 총 1140억개이며, D램은 총 128GB(기가바이트)를 탑재할 수 있다. 칩간 대역폭은 1초당 2.5TB(테라바이트)에 달한다. 애플은 CPU 성능 면에서 M1 울트라가 인텔 28코어 CPU를 탑재한 맥 프로보다 최대 60% 더 빠르다고 밝혔다.
이에 비해 CoWoS-R과 CoWoS-L은 CoWoS의 가성비 버전이다. CoWoS-R은 고가의 인터포저 대신 재배선층(RDL)을 배치해 칩들을 연결하는 방식이다. 통신 속도는 CoWoS-S 대비 느리다.
CoWoS-L은 칩 전체를 덮는 풀사이즈 인터포저 대신 로컬실리콘인터커넥트(LSI, Local Silicon Interconnect)라는 소형 인터포저를 사용한다. 칩과 칩을 연결하는 부위에만 브릿지 타입의 소형 인터포저를 배치한다.
인텔의 최신 패키지 기술인 EMIB(Embedded Multi-Die Interconnect Bridge)도 여기에 속한다.
한 반도체 후공정 업체 임원은 “M1 울트라는 CoWoS-S를 통해 물리적으로 완벽하게 연결하기도 했지만, 소프트웨어적으로도 한 개의 다이처럼 움직이게 구현한 게 혁신”이라고 설명했다.

