고성능 반도체 구현을 위한 2.5D 패키지 핵심 부품
삼성전기, 부산사업장을 베트남의 '마더 팹'으로 운영
삼성전기가 3000억원을 들여 부산사업장에 FC-BGA(플립칩-볼그리드어레이) 기판 라인을 증설한다. 삼성전기는 지난해 12월에도 베트남법인에 1조3000억원을 투자해 역시 FC-BGA 라인을 신설키로 결의한 바 있다.
최근 애플이 ‘M1 울트라’를 통해 보여줬듯, 고성능 반도체 구현을 위한 핵심 키가 2.5D 패키지와 FC-BGA라는 점을 고려한 결정이다.

삼성전기, 베트남 1.3조 이어 부산에 3000억원 투자
삼성전기는 부산사업장 내 FC-BGA 라인 증설을 위해 3000억원을 투자한다고 21일 밝혔다.
현재 삼성전기는 베트남 RF-PCB(경연성-인쇄회로기판) 라인을 FC-BGA 공장으로 전환하는 작업을 진행 중이다. RF-PCB는 스마트폰 각 부품간 신호전달을 위한 PCB인데, 지난해 채산성이 떨어져 사업 철수를 결정했다. 삼성전기는 RF-PCB를 베트남 1⋅2공장에서 제조해왔다. 이제 두 공장 모두 FC-BGA 라인으로 전용 작업이 이뤄지고 있다.
앞으로 FC-BGA 주력 생산은 베트남 공장이 담당하지만, 일부 하이엔드 제품 생산과 신제품 공정 개발은 경기도 수원 및 부산사업장이 담당할 계획이다. 국내 사업장들이 일종의 ‘마더팹(Mother Fab)’ 역할을 맡게 되는 것이다. 이번 3000억원 투자분은 이 마더팹 구축을 위해 사용된다.
삼성전기측은 “하이엔드급 패키지 기판 시장은 고속 신호처리가 필요한 다양한 응용처 수요가 늘어나면서 중장기적으로 연간 20% 수준으로 성장할 것”이라며 “ 2026년까지 패키지 기판 수급 상황이 타이트할 전망”이라고 설명했다.

2.5D 패키지의 정수, 애플 M1 울트라
삼성전기가 단일 아이템으로는 창사 이래 최대 규모로 투자하고 있는 FC-BGA는 반도체 패키지용 기판, 그 중에서도 2.5D 패키지를 위해 사용하는 부품이다.
원래 반도체들 간의 신호 전달은 일반 PCB 위에서 배선 연결을 통해 이뤄졌다. 평면 상 PCB에 여러 반도체들을 연결한다는 점에서 이를 2D 패키지라고 한다.
그러나 이 같은 방식은 신호를 주고받을 수 있는 한계(대역폭)가 명확해 고성능 반도체 패키지 방식으로는 부적합하다. 대역폭을 늘리려면 여러 반도체가 직접 커뮤니케이션 할 수 있게 다이를 수직으로 쌓는 게 유리하다. 각 다이를 적층한다는 의미로 이를 3D 패키지라고 한다.
2.5D 패키지는 2D와 3D 패키지 성격을 겸비한 기술이다. 2D처럼 반도체들이 평면상 나란히 패키지 되면서도 3D 패키지 못지 않게 빠른 신호 전달 속도를 확보할 수 있다. 3D 패키지는 전송 속도가 빠른 대신 생산 수율이 극도로 낮고, TSV(Through Silicon Via, 위아래 반도체 간 신호연결 통로) 형성을 위한 공간을 다이 상에 마련해야 한다는 점에서 다이 면적 손실도 크다. 고층 아파트에서 엘리베이터가 관통하는 면적만큼 주거공간을 내어 줘야 하는 것과 마찬가지다.
2.5D 패키지는 3D에 비하면 수율은 높고, TSV 공간 없이 다이 전체를 오롯이 쓸 수 있다는 점에서 비용 효율적이다.
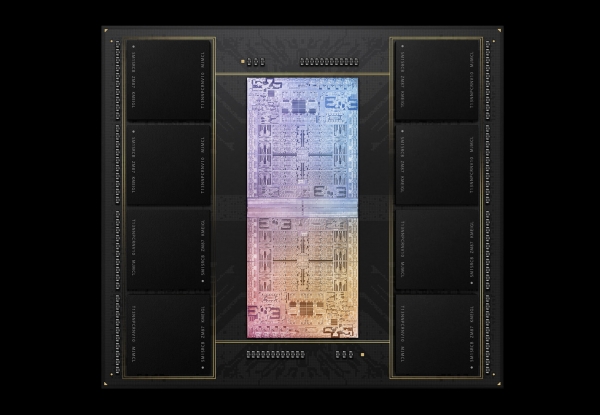
2.5D 패키지의 대표적인 제품이 애플이 최근 전문가용으로 출시한 데스크톱 CPU, M1 울트라다. M1 울트라는 FC-BGA를 이용한 2.5D 패키지의 정수를 보여주는 제품이다. M1 울트라는 지난해 10월 M1의 고급 버전으로 출시됐던 ‘M1 맥스’를 2개 이어 붙여 만들었다. 보통 반도체 2개를 이어 붙이면 물리적 성능이 저하되기 마련인데, M1 울트라는 정확히 M1 맥스의 두 배씩이다. 2개의 다이가 사실상 한 몸처럼 동작한다는 뜻이다(KIPOST 2022년 3월 12일자 <애플 'M1 울트라' 생산에 사용된 CoWoS-S 기술은?> 참조).
M1 울트라 제조를 담당한 대만 TSMC는 인터포저가 포함된 FC-BGA 상에 두 개의 M1 맥스를 함께 패키지함으로써 이 같은 성능을 확보했다. TSMC가 수년 전부터 개발해 온 ‘CoWoS’가 2.5D 패키지의 브랜드명이다. TSMC 뿐만 아니라 삼성전자⋅인텔 등 대부분의 반도체 업체들이 2.5D 패키지를 고성능 반도체 패키지를 위한 솔루션으로 내세우고 있다.
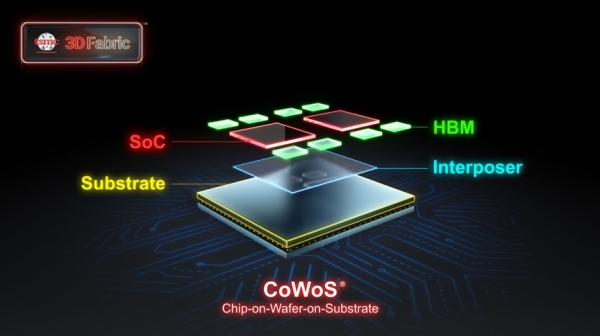
이처럼 2.5D 패키지가 고성능 반도체 구현의 핵심으로 떠올랐지만, 필수 부품인 FC-BGA 공급은 원활하지 않다. 일본 이비덴⋅신코, 대만 유니마이크론 정도를 제외하면 최근 몇년간 투자에 소극적이었던 탓이다. 삼성전기는 지난해 연말부터 부랴부랴 투자를 늘리고 있고, LG이노텍도 이제 막 파일럿 라인을 꾸리는 정도다. 삼성전기가 2026년까지 FC-BGA 업황 호조를 예상하는 이유다.
한 반도체 후공정 업체 임원은 “국내서 대덕전기⋅코리아써키트 등 중견 PCB 업체들이 상대적으로 일찍 FC-BGA 투자를 진행해왔으나 아직 기술면에서 이비덴이나 유니마이크론에 비할 바는 못 된다”며 “요즘 하이엔드급 FC-BGA는 품귀가 가장 극심한 전자부품 중 하나”라고 말했다.

