CMP로 인한 디싱, 너무 깊어도 너무 얕아도 불량
디싱 미세 제어하는 장비는 오직 어플라이드만
차세대 본딩 기술로서 ‘하이브리드 본딩’이 부각되고 있지만 전용 CMP(화학적기계연마) 장비 국산화는 요원하다. CMP 장비 전체로 보면 이미 국산화가 상당히 진전된 품목이긴 하나 하이브리드 본딩 공정에 쓰기 위해서는 디싱(Dishing) 제어 수준을 현저히 높여야 하는 탓이다.
반도체 업계는 이 방면에서 글로벌 업체와 국내 업체 간 실력차가 최소 수년 이상 나는 것으로 보고 있다.
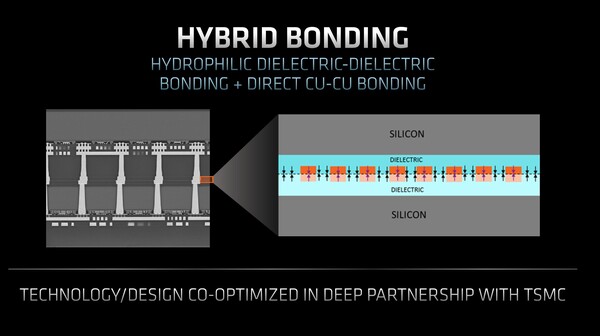
CMP로 인한 디싱, 너무 깊어도 너무 얕아도 불량
하이브리드 본딩은 두 개 이상의 웨이퍼와 이종 칩을 이어 붙일 때, 별도의 솔더볼이나 범프 없이 직접 맞대는 기술이다. 반도체 표면의 유전체(SiO2) 부위와 구리 부위가 한번에 접합된다는 점에서 하이브리드 본딩이라는 이름이 붙었다.
하이브리드 본딩 공정에서 CMP가 사용되는 시점은 첫 과정인 표면 가공에서부터다. 두 웨이퍼 표면을 붙이기 전 유전체⋅구리가 노출된 표면을 CMP로 매끈하게 평탄화시켜야 한다.
다만 이 과정에서 디싱 이슈가 발생한다. 디싱은 유전체 대비 상대적으로 평탄화 속도가 빠른 구리 표면이 과하게 침식돼 나가는 현상이다. 구리 가운데 부분이 오목하게 깎여 들어가 접시처럼 보이기에 디싱이라고 부른다. 디싱을 피하기 위해 CMP 공정 시간을 줄이면 반대로 유전체가 덜 평탄화되는 문제가 발생한다.
그동안 증착⋅식각 전후로 이뤄지던 여타 CMP 공정에서도 디싱이 발생했지만 수율에 직접적인 영향을 줄만큼 문제가 된 바는 없다.
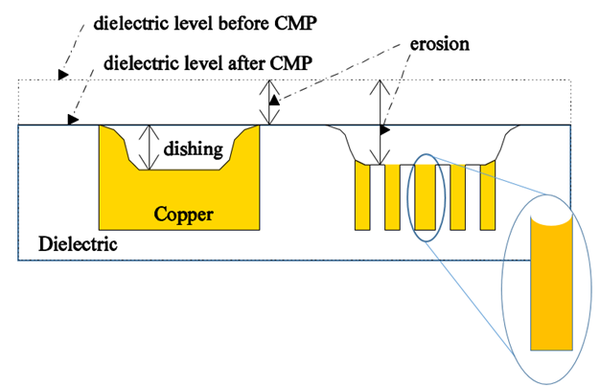
그러나 하이브리드 본딩은 디싱을 어떻게 제어하느냐가 이후 공정에서의 수율을 결정한다. 하이브리드 본딩시 두 장의 웨이퍼는 별도의 접착제 없이 유전체 사이의 반데르발스 힘(van der Waals force)만으로 이어 붙인다. 반데르발스 힘은 가까운 거리에서 분자 사이에 작용하는 밀거나 당기는 힘을 뜻한다.
만약 구리 표면에 디싱이 과하게 발생하면 구리와 구리 사이의 연결이 불완전하게 이어지는 문제가 발생한다. 심하게는 아래위 반도체 사이에 신호 및 전력 전달이 이뤄지지 않아 불량 처리되기 십상이다.
그렇다고 구리 표면에 디싱이 아예 없는 수준으로 CMP 공정을 진행해서도 안 된다. 반데르발스 힘으로 불완전하게 붙은 두 웨이퍼는 이후 어닐링 공정에서 고온(약 150~350℃ 사이)을 가해 완전하게 결합시킨다. 이때 유전체⋅구리가 각각 열에 의해 팽창한다. 유전체와 구리는 열팽창하는 속도가 다르며, 상대적으로 구리가 더 크게 팽창한다. 과팽창된 구리는 인접 유전체의 결합력을 떨어뜨린다.
철근⋅콘크리트 구조물은 사계절 온도 변화에 따른 팽창 정도가 거의 비슷해서 무너지지 않는데, 유전체⋅구리는 이러한 장점을 누릴 수 없다.
따라서 구리가 과하게 팽창할 것을 미리 감안해 약간의 디싱을 만들어 놓아야 어닐링 공정에서 유전체⋅구리 모두 완벽하게 접합할 수 있는 것이다.
한 반도체 산업 전문가는 “구리가 너무 많이 깎여도, 디싱이 아예 없어도 안 되기 때문에 하이브리드 공정에서 CMP 기술의 중요도가 크게 높아졌다”고 말했다.
하이브리드 본딩용 CMP, 어플라이드 천하
그동안 반도체 CMP 장비는 국내서 케이씨텍이 국산화에 성공, 삼성전자⋅SK하이닉스 모두에 양산 공급했다. 전공정 장비 중 국내 업체가 두자릿수 이상의 점유율을 보유한 몇 안 되는 품목이 CMP다.
그러나 하이브리드 본딩 공정에 쓰이는 CMP는 케이씨텍은 물론 일본 에바라도 넘보지 못하는 영역이다. 오직 미국 어플라이드머티어리얼즈(이하 어플라이드)만이 관련 장비를 양산 라인에 공급하고 있다.
어플라이드는 공정 조건에 따라 CMP 슬러리(연마액) 온도를 실시간 변경시키는 방법으로 디싱을 제어한다. CMP 공정은 웨이퍼 표면에 슬러리를 뿌리고 CMP 패드로 문질러주는 방식으로 진행된다. 이때 슬러리는 주변 온도에 따라 활성도가 달라지는데 특정 온도에서는 구리만 연마하거나, 혹은 유전체만 연마하게 컨트롤 할 수 있다.
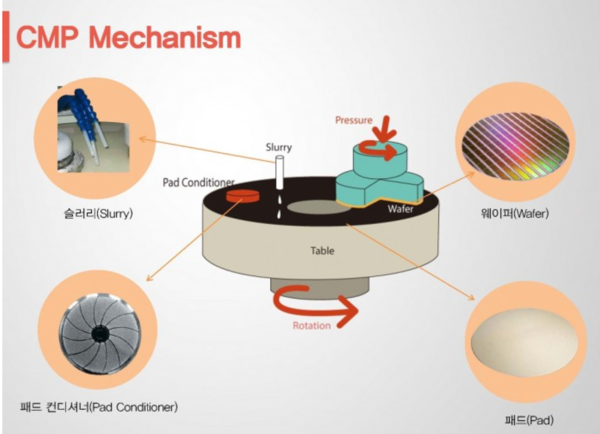
다만 어떠한 온도에서 슬러리가 어떻게 반응하는지는 각 반도체 업체 고유의 레시피며, 이를 미세하게 조절할 수 있는 장비는 현재는 어플라이드 제품이 유일하다.
또 다른 반도체 산업 전문가는 “디싱 제어 기술만 놓고 보면 어플라이드와 케이씨텍⋅에바라 간의 기술 격차가 10년 가까이 나는 것으로 보인다”며 “향후 점차 늘어날 하이브리드 공정에도 불구하고 어플라이드가 사실상 CMP 장비 시장에서 독점력을 구가할 것”이라고 말했다.

