닛산케미컬⋅쇼와덴코, 양산 시설 투자
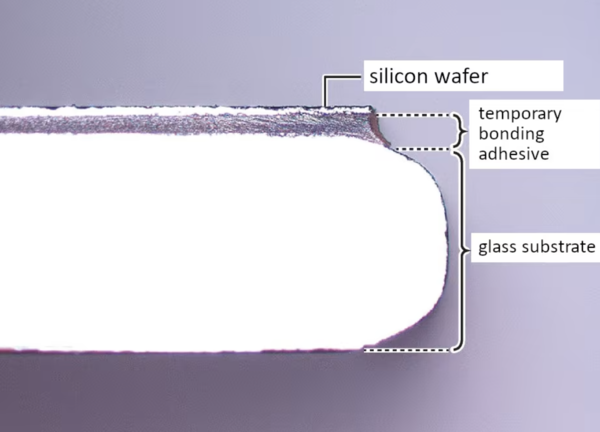
일본 반도체 소재 회사들이 3D 패키지용 소재 분야에 투자를 확대하고 있다고 닛케이아시아가 3일 보도했다. 3D 패키지는 반도체 웨이퍼를 수직 적층하는 후공정 기술이다. 미세공정 발전이 한계에 봉착하면서 TSMC⋅인텔 등 전공정 회사들은 3D 패키지를 통한 반도체 성능 개선에 골몰하고 있다. 닛산케미컬⋅쇼와덴코 등 전통의 반도체 소재 회사들이 3D 패키지용 소재 생산능력 확대에 투자하는 이유다.
닛산케미컬은 일본 도요마 공장에 3D 패키지용 점착소재 양산 시설을 도입하고 있다. 현재 이 회사는 이를 샘플 정도만 공급하고 있는데, 2024년부터 고객사에 양산 공급하기 위해 생산능력을 확대하는 것이다. 3D 패키지용 점착소재는 실리콘 웨이퍼를 글래스캐리어에 붙이기 위해 사용하는 소재다. 실리콘 웨이퍼는 글래스캐리어에 붙은 상태로 폴리싱 공정이나 스태킹 공정을 수행한다. 모든 공정이 끝난 뒤에는 실리콘웨이퍼에 손상을 주지 않고 점착소재⋅글래스캐리어가 탈락된다.
닛산케미컬은 아시아에서 반도체 노광공정용 반사방지 코팅 소재 시장의 70%를 점유하고 있다. 2024년 3D 패키지 소재 분야에서만 10억엔(약 100억원) 정도의 매출을 기록할 것으로 전망하고 있다.
쇼와덴코는 CCL(동박적층판) 생산능력 확대를 위해 2025년까지 100억엔을 투자하기로 했다. 투자가 끝나면 이 회사 CCL 생산능력은 현재의 2배 수준으로 늘어날 전망이다. CCL은 기본적으로 PCB(인쇄회로기판)용 소재지만 반도체 3D 패키지를 위한 서브스트레이트 자재로도 쓰인다.
또 다른 패키지 소재 업체 나가세는 여러장의 웨이퍼를 적층해도 뒤틀림이 발생하지 않는 인캡슐레이션(봉지) 소재를 개발하고 있다. 곧 양산 투자에 나설 전망이다.
시장조사업체 후지게이자이에 따르면 반도체 후공정 소재 시장은 오는 2026년까지 30% 성장한 42억달러(5조5000억원)를 기록할 전망이다.

