FoWLP 개발하는 '김기남 프로젝트'와 경쟁관계
PLP 독자 생존 위해 차별화 절실
지난달 삼성전자로 이관된 반도체 패널레벨패키지(PLP) 사업이 당초 삼성전기에 있을때 보다 격이 축소된 모양새다. 삼성전기에서 사장 직속으로 PLP 사업을 이끌던 강사윤 부사장이 삼성전기에 잔류하면서, PLP 사업은 삼성전자 TSP(Test & System Package) 총괄 산하로 편입됐기 때문이다.
삼성전자가 모바일 어플리케이션프로세서(AP)용으로 팬아웃웨이퍼레벨패키지(FoWLP) 기술을 따로 개발하고 있었다는 점도 PLP의 위상을 애매하게 만들고 있다.

PLP 이끌던 강사윤 부사장, 삼성전기 잔류
올해 5월까지 삼성전기에서 PLP 사업을 이끌던 ‘투톱’은 강사윤 부사장과 조태제 전무다. 둘 다 삼성전자 패키지 개발팀 출신으로, 후공정 부문 핵심 인재다. PLP 사업의 삼성전자 이관설이 나오던 올해 초부터 두 사람의 거취에 관심이 쏠린 이유다.
지난 6월 1일자로 삼성전자로 사업이 이관되었지만, 강사윤 부사장은 삼성전기에 남았다. 현재 이윤태 사장 직할 부사장으로 신사업업무를 담당하고 있다. 인쇄회로기판(PCB)을 생산하는 삼성전기 기판부문에서 새로운 사업을 모색하는 역할을 맡는 것으로 보인다. 삼성전기 관계자는 “강 부사장이 삼성전자로 옮기기에는 직급상 너무 무거워 삼성전기 안에서 새 업무를 맡는 걸로 결론났다”고 말했다.

따라서 현재 삼성전자에서 PLP 개발은 조태제 전무가 이끌고 있다. 조 전무는 삼성전기 PLP개발팀장에서 삼성전자 TSP(Test & System Package)총괄 PLP개발팀장으로 소속만 바뀌었다. 역할은 동일하다.
다만 TSP 내 개발실은 현재 FoWLP 개발에 여념이 없는 상태다. 인텔 출신의 패키지 전문가 오경석 상무가 지난 2017년부터 관련 프로젝트를 이끌고 있다. 김기남 사장이 비밀리에 FoWLP 개발을 지시하면서 이른바 ‘김기남 프로젝트’라는 이름이 붙었다. 이 때문에 PLP개발팀은 개발실과는 별도로 TSP 총괄 내에 직제된 것으로 보인다.
FoWLP와 PLP는 기판 없이 한번에 패키징 공정을 수행할 수 있어 원가가 저렴하고, 공정이 줄어든다는 점에서 동일하다. 다만 FoWLP는 동그란 웨이퍼 위에서, PLP는 직사각형의 패널 위에서 공정이 진행된다는 점만 다르다. 이론상 생산능률은 PLP가 더 높다. 패널이 크고 직사각형 형태기 때문이다.
그러나 관련 소재⋅장비 생태계가 활성화된 FoWLP와 달리, PLP는 삼성전기가 처음 양산을 시도했던 기술이라는 점에서 생태계가 미비하다. 두 기술을 모두 검토했던 대만 TSMC도 결국 FoWLP를 통해 애플 AP 물량을 독식할 수 있었다.
힘 빠진 PLP, 독자생존 할 수 있을까...인텔 행보 주목
삼성전자가 삼성전기에서 관련 사업을 인수할 때, 사실상 실비 정도(7850억원)만 지급한 것도 삼성전자의 PLP에 대한 낮은 사업의지를 반영한 것으로 보는 시각도 있다. 삼성전기가 2015년부터 올해 초까지 PLP 사업에 투자한 금액은 대략 5000억~6000억원 정도다.
이는 설비투자와 연구개발(R&D)에 따르는 비용만 계산한 것으로, 각종 간접비와 기회비용까지 감안하면 실제 들인 돈은 이를 크게 상회한다. 만약 삼성전자가 PLP 사업을 유망하게 바라봤다면 7850억원보다는 높은 가격에 인수했을 것이라는 게 중론이다. 자칫하다가는 지난 2012년 삼성전자가 흡수합병한 삼성LED처럼 반도체 사업부 내에서 존재감이 쪼그라들 가능성도 적지 않다.
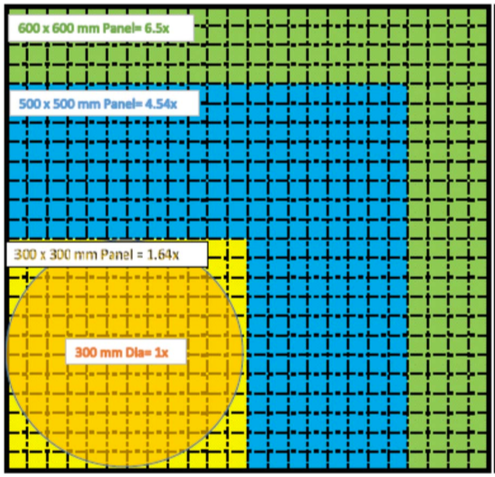
업계 관계자는 “삼성전자가 이미 FoWLP로 차세대 패키지 방향성을 결정한 뒤 PLP 사업이 이관됐다”며 “삼성전자 스스로의 의지로 인수했다기 보다는 그룹 차원의 교통정리로 봐야 한다”고 말했다.
따라서 향후 삼성전자 안에서 PLP 사업이 생존하기 위해서는 경쟁기술인 FoWLP와 차별화되는 시장을 공략해야 할 것으로 보인다. 이와 관련 최근 인텔의 행보가 눈에 띈다(KIPOST 2019년 7월 11일자 <인텔, 이기종 패널레벨패키지(PLP) 준비 본격화>참고).
인텔은 이기종(異機種) 반도체 패키지 기술로서의 PLP를 연구개발하기 시작했다. 그동안 삼성전자⋅삼성전기는 한 패널 위에서 AP면 AP, 전력반도체(PMIC)면 PMIC 등 한 종의 반도체만 패키지 하는 기술로 PLP를 바라봤다. 인텔은 마치 시스템인패키지(SiP) 기술처럼 여러 종류의 반도체를 한번에 패키지하기 위해 PLP에 대한 R&D를 시작했다.
PLP는 패널 그 자체가 기판 역할을 한다. 패널 위에 여러 반도체 다이(die)를 올려놓고 한 번만 패키징하면 마더보드 하나가 뚝딱 생긴다. 별도 기판이 사라지기 때문에 패키지 두께를 줄이고 성능은 개선할 수 있다.

물론 이기종 PLP를 위해서도 미세화 수준(L/S)는 현재보다 훨씬 향상시켜야 한다. 고성능 반도체를 패키징하려면 L/S가 적어도 2마이크로미터(㎛) 이하는 돼야한다. 하지만 업계는 아직 10㎛도 달성하지 못했다.
업계 관계자는 “AP 등 단일 반도체를 위한 패키지는 FoWLP가 독식할 것으로 봐야 한다”며 “PLP가 독자 생존하기 위해서는 FoWLP와 차별화되는 기술로 승부해야 할 것”이라고 말했다.

