관련 특허(IP) 소수 업체에 집중… 후발주자 회피 힘들어
# 지난해 미국 특허(IP) 전문 업체 테세라는 삼성전자를 상대로 반도체 후공정(패키징) 및 이미지 기술을 웨이퍼레벨패키징(WLP) 기술 관련 특허침해 소송을 냈다. 업계는 이 사건을 특허 전쟁의 전조징후라고 보고 있다.
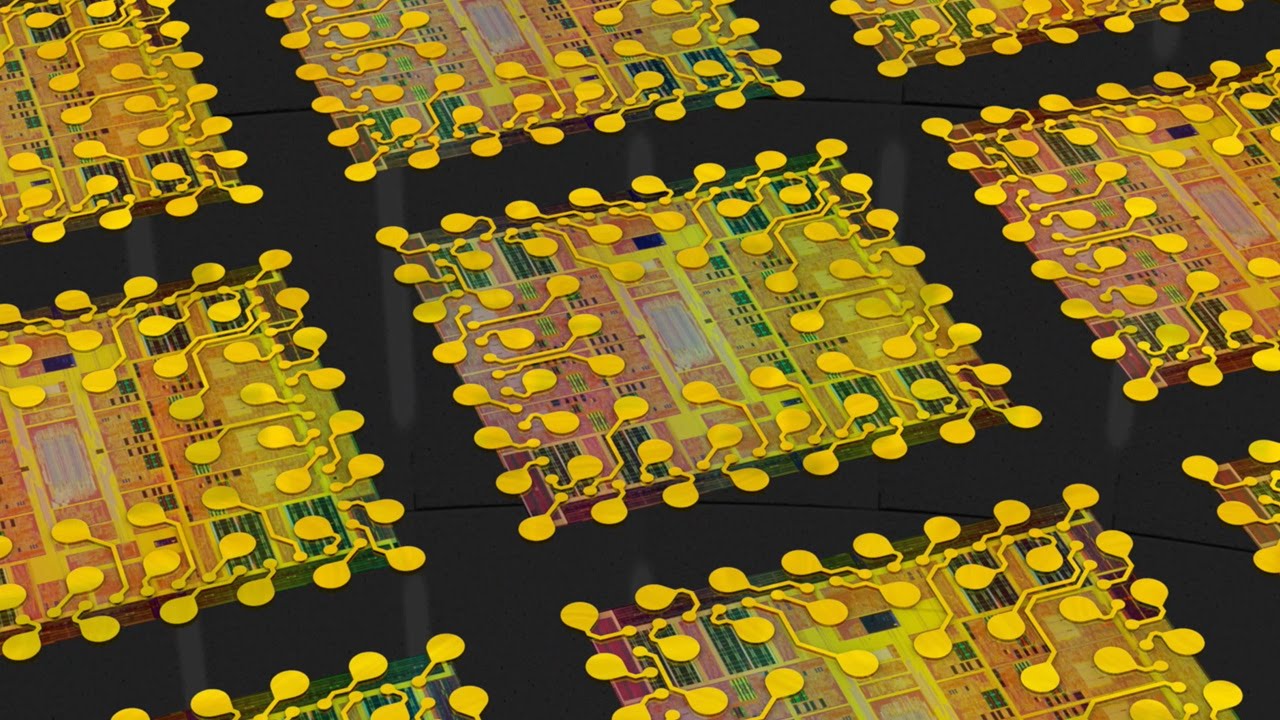
주요 OSAT 업체가 팬아웃웨이퍼레벨패키지(Fo-WLP) 양산에 돌입하면서 본격적인 특허 소송이 시작될 것이라는 얘기가 나온다. 이유는 10여개사가 독점하고 있는 관련 특허를 회피하기 쉽지 않기 때문이다.
가지각색 Fo-WLP 구현 방식, 인피니언 ‘eWLB’로 표준화
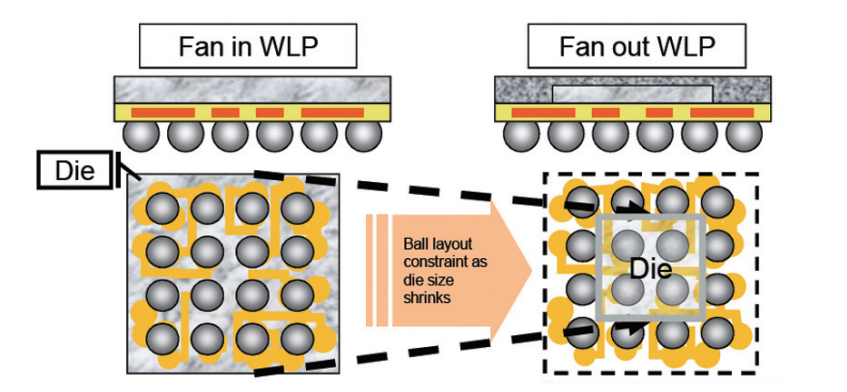
▲팬인웨이퍼레벨패키지(Fan-in WLP)와 팬아웃웨이퍼레벨패키지 기술 비교. 팬인웨이퍼레벨패키지는 웨이퍼레벨칩스케일패키지(WLCSP)로도 불린다./전북테크노파크
Fo-WLP는 반도체의 입출력 단자와 메인 보드 전극을 연결할 때, 인쇄회로기판(PCB) 없이 바로 연결하는 기술이다. 수백 마이크로(㎛) 두께의 PCB 대신 폴리머 층과 도전층을 적층한 수십 마이크로 두께의 재배선층(RDL)을 두 전극 사이에 형성한다.
PCB도, PCB와 반도체를 연결하기 위한 와이어나 범프도 필요 없기 때문에 패키지 두께를 줄일 수 있고, 원가 경쟁력도 확보할 수 있다. RDL 층을 칩 바깥 부분으로 뺄 수 있어 입출력 단자의 밀도가 높은 칩에 유리하고 전기적 성능도 좋다.
초기 업계는 여러 방식으로 Fo-WLP를 구현했다. 프리스케일(NXP반도체에 인수)이 ‘RCP(Redistributed Chip Packaging)’ 기술을 처음 선보였고, 인피니언이 ‘eWLB(Embedded Wafer Level Ball Grid Array)’ 기술을 뒤이어 내놨다.
이 중 ASE, JCET, 앰코테크놀로지 등 주요 OSAT 업체들이 선택한 기술은 인피니언의 ‘eWLB’다. 상대적으로 공정이 단순하고 제조 비용이 저렴하기 때문이다.
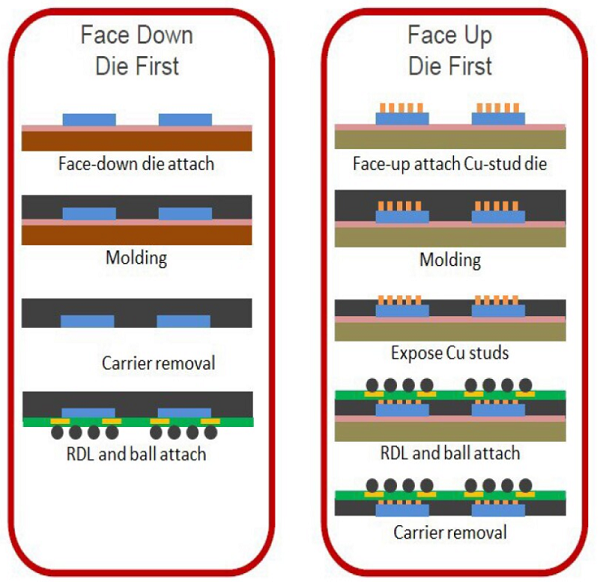
▲인피니언의 ‘eWLB’는 ‘Die First/Face down’(왼쪽) 방식을, 프리스케일의 ‘RCP’는 ‘Die First/Face up’ 방식을 쓴다./SPIL
‘eWLB’는 웨이퍼에서 각 다이(Die)를 잘라 캐리어(Carrier) 웨이퍼에 옮겨놓고 에폭시몰딩컴파운드(EMC)로 몰딩, 캐리어를 제거한 뒤 뒤집어서 재배선층을 형성하는 ‘Die First/Face down’ 방식이다.
반면 ‘RCP’는 캐리어에 다이를 올린 후 다이 위에 구리 기둥을 형성한다. 이후 EMC로 이를 감싸고 연마해 윗부분에 재배선층을 만드는 ‘Die First/Face up’ 방식이다. 즉, 구리 기둥이 칩의 이동(die shift)을 막고 전기적 성능을 강화하는 역할을 하는 셈이다.
초기 ‘eWLB’ 기술은 I/O 숫자가 적은 반도체에만 활용됐지만, 일찍이 라이선스를 받은 주요 OSAT 업체들이 성능 개선에 집중하면서 현재는 1000여개 이상의 I/O를 가진 2D 반도체는 물론 2.5차원(2.5D), 3D 반도체까지도 구현할 수 있게 됐다.
OSAT 업계 관계자는 “‘eWLB’ 기술의 주 고객은 퀄컴이었지만, 최근 5세대(5G) 이동통신용 무선통신(RF) 칩이나 미세기계전자시스템(MEMS), 차량용 반도체 시장에서도 이를 도입하려하고 있다”며 “I/O 밀도는 높지 않지만 단가 경쟁력과 성능 개선을 동시에 확보해야하는 반도체에 적합하다”고 말했다.
상위 업체에 집중된 Fo-WLP 관련 특허… 특허 전문 업체도 등장
두 기술은 공정 흐름은 서로 다르다. 하지만 재배선층 형성이나 EMC 몰딩, 전자파잡음(EMI) 차폐 등 상당 부분이 겹친다.
문제는 소수 업체만 라이선스를 받아 생산과 연구개발하다보니 관련 특허 또한 몇 개 업체만 쥐고 있다는 점이다. 특히 최근 2~3년간 이 업체들은 관련 특허를 봇물처럼 쏟아냈다.
시장 조사 업체 욜디벨롭먼트에 따르면 지난 2016년까지 Fo-WLP 관련 특허는 약 3100건으로, 10여개사에 집중돼있다.

▲팬아웃웨이퍼레벨패키지(Fo-WLP) 특허 중 가장 광범위한 포트폴리오를 갖춘 곳은 스태츠칩팩(STATSChipPAC)을 인수한 JCET다./욜디벨롭먼트
가장 특허 경쟁력이 강한 업체는 스태츠칩팩(STATSChipPAC)을 인수한 중국 JCET다. ‘eWLB’ 기반 특허를 광범위하게 갖추고 있고, 업계가 연구개발(R&D) 중인 선행 기술에 대한 특허를 다수 확보한 상태다.
독자적인 인포(InFO) 기술을 활용하고 있는 TSMC는 지난 2011년부터 관련 특허를 출원하기 시작, 5년만에 160개 이상의 관련 특허를 확보했고 현재는 200여개가 넘는 것으로 추정된다. TSMC가 보유한 특허는 대부분 존속기간 15년 이상이다.
특허 전문 업체도 속속 등장하고 있다. 인피니언은 자회사 형태로 IP 라이선스 업체 ‘폴라리스이노베이션(Polaris Innovations)’을 출범시켰다. 삼성전자에 소송을 건 테세라는 물론 와이랜(WiLAN) 등 IP 라이선스 업체들도 관련 특허를 출원하고 있다.
후발주자 진입 박차… NXP반도체 가세 가능성
중국 OSAT 업체 등 후발주자들도 Fo-WLP 기술 확보에 전념하고 있다. 저가형 반도체 시장을 공략하겠다는 전략이다. 삼성전자가 패널레밸패키지(PLP)에 집중하는 것도 이같은 특허를 회피하기 위한 차원으로 분석된다.
화천과기(Tianshui Huatian)는 ‘eSiFO’라는 독자 기술을 개발했다. 캐리어 웨이퍼를 식각해 갭(gap)을 형성하고 다이를 매립시킨 뒤 에폭시 물질을 채워 넣는 방식이다. 고객사는 중국 반도체 업체로 I/O 숫자가 낮은 저밀도 반도체에 적용된다.
업계에서는 라이선스 경쟁에서 밀린 NXP반도체가 중국 OSAT 업체에 라이선스를 내줄 가능성도 높다고 내다본다.
업계 관계자는 “NXP반도체의 ‘RCP’ 진영이 수율 확보는 물론 불량 때문에 골머리를 앓았다”며 “기술 발전을 위해서는 eWLB 진영처럼 시장 플레이어를 늘리는 게 빠르다”고 설명했다.
실제 NXP반도체는 중국 기업들과 차량용 반도체에 관한 협력을 늘리고 있다. 현재 ‘RCP’ 기술이 적용되는 대부분의 제품이 레이더(radar)를 포함한 차량용 반도체다.
NXP반도체는 지난해 충칭에 차량용 반도체 연구개발(R&D) 조직 ‘NXP 차이나 전장부품 애플리케이션 개발 센터(NXP China Applications Development Center for Auto Electronics)’를 세우겠다고 밝힌 바 있다.
바이두, 알리바바 등 중국의 주요 대기업과도 손을 잡았다. 바이두의 자율주행 개발 오픈 플랫폼에 참여하고 있고, 자동차는 물론 인공지능(AI), 사물인터넷(IoT) 등으로 협력 범위를 넓혀가고 있다.
또다른 업계 관계자는 “NXP반도체와 중국 OSAT 업계가 협업하면 시장 구도는 eWLB 대 RCP로 나뉘게 될 것”이라며 “두 기술에 비슷한 점이 많은 만큼 eWLB 진영에서는 시장을 수성하기 위해, RCP 진영에서는 시장에 진입하기 위해 서로 특허 전쟁을 벌일 가능성이 크다”고 말했다.

