불투명한 수요에 리스크 관리키로… '스위프트(SWIFT)' 양산 미뤄
앰코테크놀로지코리아가 차세대 후공정(Advanced Packaging) 생산 거점인 인천 송도 K5 사업장에 대한 투자 일부분을 미루기로 결정했다. 하반기 양산은 시작하지만, 시황을 감안해 추가 투자 여부를 결정할 계획이다.

▲앰코테크놀로지의 차세대 후공정(Advanced Packaging) 생산 거점인 인천 송도 K5 사업장 조감도./앰코테크놀로지
외주반도체패키지후공정(OSAT) 업체 앰코테크놀로지는 오는 7월 송도 K5 사업장 양산을 시작할 예정이다. 공정 안정화를 거쳐 8월부터 본격적으로 제품을 출하할 것으로 보인다.
송도 K5 사업장에서는 플립칩(FC), 2.5D 패키지, 팬아웃웨이퍼레벨패키지(FoWLP) 등 각 공정별 생산 라인이 구축된다. 이 중 먼저 가동되는 것은 플립칩과 2.5D 패키지 라인이다.
투자 계획 일부 연기… 생산량 줄어
투자 규모는 계획보다 줄었다. 당초 300㎜ 웨이퍼 기준 월 10만장 규모의 설비 투자를 할 계획이었지만, 이 중 상당부분이 미뤄졌다.
2.5D 반도체 패키징 공정은 전공정 업체가 실리콘관통전극(TSV)으로 인터포저와 웨이퍼에 구멍(비아 홀)을 형성하면, 이를 받아와 얇게 가공하고 뒷면 범프를 만들어 적층하는 방식으로 진행한다.
핵심 기술인 비아 형성을 전공정 업체가 맡기 때문에 상대적으로 수익성이 떨어진다.
FoWLP 관련 생산 라인은 저밀도 반도체용 임베디드웨이퍼레벨패키지(eWLP) 프로세스를 기반으로 구축됐다.
고밀도 반도체용 FoWLP 기술 ‘스위프트(SWIFT)’ 투자는 미뤄졌다. 스위프트는 고분자 캐리어(Carrier) 기판에 재배선계층(RDL)을 구현, 칩과 칩이나 칩과 기판을 연결하는 기술이다. 저밀도 반도체부터 수율을 확보, 추가 투자 여부를 결정하겠다는 전략이다.
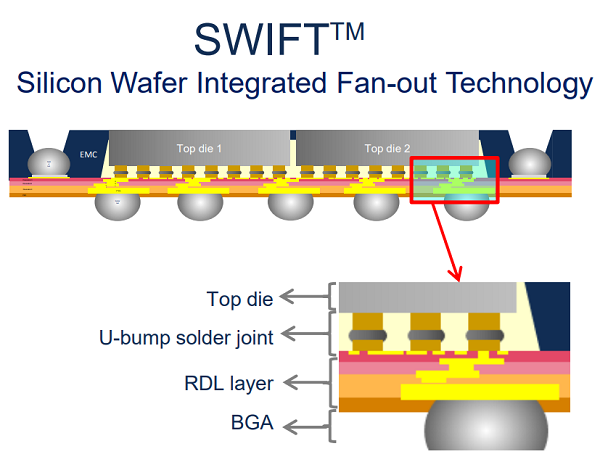
▲앰코테크놀로지의 고밀도 반도체용 팬아웃웨이퍼레벨패키지(FoWLP) 기술 '스위프트'의 구조도./앰코테크놀로지
수요 예측 어려워지고 전방 시장도 악화
이처럼 투자가 축소된 이유는 시장 수요가 예상보다 적고, 미래 수요도 예측하기 힘들어졌기 때문이다.
특히 반도체 외주생산(Foundry) 업체가 첨단 후공정을 내재화하면서 굳이 OSAT 업체에 패키징을 맡길 필요가 없어졌다. 실제 세계 1위 파운드리 업체 TSMC는 대형 고객사에 한해 후공정을 무상 혹은 저가로 제공하고 있는 것으로 알려졌다.
시장 상황도 좋지 않다. 앰코의 매출 절반은 모바일용 반도체가 차지한다. 시장 성장세가 꺾인 데다 지난해 애플 아이폰X 판매 부진으로 받은 타격이 컸다. 신규 시장인 차량용·산업용 반도체는 첨단 공정보다 안정된 구공정을 선호한다.
지난해 유럽 최대 OSAT 업체 나니움(NANIUM)과 일본 최대 OSAT 업체 제이디바이스(J-Device)를 인수하고, 광주 K4 사업장을 증설하면서 회사 전체 생산능력이 늘어난 탓도 있다.
앰코테크놀로지 관계자는 “미래 수요가 불투명해져 위험(리스크) 관리 차원에서 투자가 연기됐다”고 설명했다.
또다른 회사 관계자는 “고가의 첨단 후공정 기술을 대체할 수 있는 솔루션을 집중적으로 연구개발(R&D)하고 있다”며 “5G 이동통신 시대가 시작되면 시황이 개선될 것으로 본다”고 말했다.

