파트너와 공동 개발
TSMC가 세계 첫 3D IC 패키징 기술을 완성하고 2021년 양산할 계획이다. 이같은 내용을 전한 대만 경제일보에 따르면 이 3D IC 패키징 기술이 주로 향후 애플의 차세대 프로세서 5nm 이하 첨단 공정에 도입될 예정이다. 인공지능(AI)과 신형 메모리 반도체를 결합한 이형 칩 사전 제작 준비에 나선 상황으로 애플에 독점 공급될 것이란 예측이다.
보도에 따르면 업계에서는 TSMC의 3D IC 패키징 양산이 이뤄진다는 것이 글로벌 칩 후방 패키징의 진정한 3D 신기원을 여는 일이라는 평가를 내놓고 있다. TSMC가 첨단 공정 강점을 기반으로 후방 패키징 기술을 결합해 우위를 강화시킬 수 있을 것이란 분석이다.
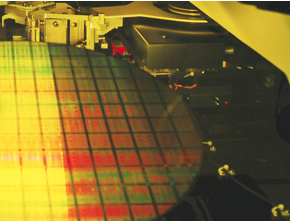
패키징 기술은 최근 칩의 스택을 통해 성능을 높이는 핵심 툴이 되고 있다. TSMC는 최근 몇 년간 CoWoS와 InFo 기술을 내놓으면서 고객의 요구에 대응, 반도체 제조부터 후방 패키징 결합 서비스를 제공하고 있다.
경제일보가 인용한 TSMC에 따르면 CoWoS와 InFo가 여전히 2.5D IC 패키징 단계지만 칩의 효율을 강화하기 위해 업계가 상당한 공력을 들이고 있다. 체적이 작고 기능은 더 복잡한 3D IC 개발은 난도가 더 높은 TSV, 웨이퍼 박막화와 전도재질 진공, 웨이퍼 연결과 발열 지원 등 기술이 동반돼야 한다는 입장이다.
비록 TSMC가 아직 협력 파트너를 공개하지는 않았지만 업계에서는 3D IC 패키징 기술 난도가 높기 때문에 첨단 프로세서, 데이터 칩, 고주파 메모리, CMOS 영상 센서, MEMS 등에 쓰이는 만큼 이같은 기술을 가진 글로벌 기업과 손잡고 있는 것으로 보고 있다. TSMC의 개발 로드맵에 따르면 애플은 3D IC 패키징 기술을 도입하는 첫 고객이 될 것으로 점쳐지고 있다.

