EV그룹, 모놀리식 3D(M3D) 구현 가능한 본딩 시스템 출시
로직 반도체의 미세화가 한계에 부딪히면서 업계는 하나의 다이(Die)를 여러 개 쌓아올리는 모놀리식 3차원(M3D) 구조를 로드맵에 넣었다. M3D 구조를 구현하기 위해서는 다이가 그려진 두 장의 웨이퍼를 서로 접합해야하는데, 이 때 표면 사이에 공기 방울이 생기는 보이드(Void) 현상이 발생하기 십상이다.
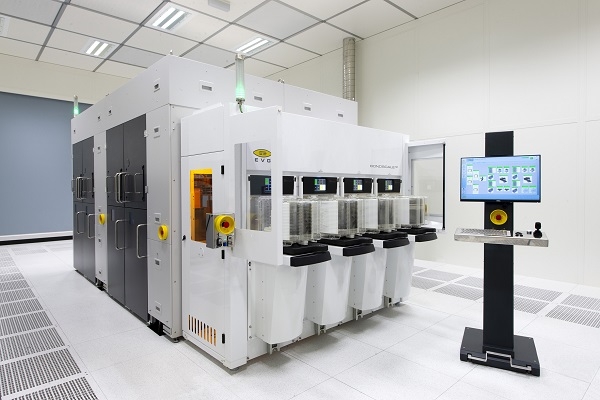
EV그룹(EVG)은 보이드 현상이 없는 전공정(FEOL) 전용 본딩 시스템 ‘본드스케일(BONDSCALE)’을 출시했다고 22일 밝혔다.
직접 접합(Direct bonding) 기술은 접착제나 중간 삽입층(Intermediate Layer) 없이 두 표면의 접합력을 높여 표면을 붙이는 기술이다. 실리콘 웨이퍼와 또다른 실리콘 웨이퍼를 접합할 때 주로 사용되며, 퓨전 접합(Fusion bonding)으로도 불린다.
직접 접합 방식 중에서도 플라즈마 활성화 기술을 이용하면 서로 다른 재료들과 실리콘 웨이퍼, 기판 사이 집적화가 용이하다. '본드스케일'은 세정, 플라즈마 활성화(Plasma Activation), 정렬(Alignment), 사전 본딩 및 적외선(IR) 검사 등 관련 모든 단계를 하나의 장비에서 수행한다.
직접 접합 공정의 수율을 높이려면 두 웨이퍼의 표면이 깨끗하고 평평해야하는데, 관련 공정을 장비 안에서 모두 처리하기 때문에 보이드 현상에서 자유롭다. 200㎜ 웨이퍼와 300㎜ 웨이퍼를 모두 처리할 수 있고 본딩 시 웨이퍼 가장자리가 틀어지지 않도록 '엣지 정렬' 기능을 강화해 수율이 높다.
폴 린드너(Paul Lindner) EVG 최고기술책임자(CTO)는 “25년 전, EVG는 틈새 시장용 고주파 및 방사선 경화 방법을 디바이스 생산에 활용할 수 있는 업계 최초의 실리콘온인슐레이터(SOI) 웨이퍼 본딩 장비를 출시했다"며 "그 이후로, 우리는 고객들이 첨단 공업용 기판의 이점을 보다 폭넓은 애플리케이션에서 활용할 수 있도록 하기 위해 EVG 직접 접합 플랫폼의 성능과 총 소유비용(CoO)을 지속적으로 강화해왔다"고 말했다.

